如何優化中溫無鉛錫膏的回流時間


如何優(you) 化中溫無鉛錫膏的回流時間
中溫無鉛錫膏的熔點介於(yu) 低溫無鉛錫膏和高溫無鉛錫膏之間。對於(yu) 需要多次回流封裝的廠家,中溫錫膏的熔點在210多攝氏度左右,能夠適用於(yu) 多次回流中的第一次回流。錫銀銅305 (SAC305)無鉛錫膏的熔點為(wei) 217℃,在不極端的條件下比SnPb具有更好的抗熱疲勞性能,因此得到了廣泛使用。但是SAC錫膏在回流過程會(hui) 生成金屬間化合物並影響焊點機械強度,因此為(wei) 了保證良好的可靠性,需要對SAC錫膏回流做出優(you) 化。
為(wei) 了找出最合適的回流時間,需要完成一係列的實驗。比如Gong等人(2021)使用SAC305錫膏采取不同回流時間對銅片進行焊接後,將焊點機械強度進行對比。並與(yu) SnZn9Bi2.5In1.5進行了比較。下表羅列了回流實驗的參數。機械強度實驗以100μm/s的推力速度在基板上方150μm的高度水平移動,直到銅片剝落。
表1. 回流實驗參數。

結論
SAC305無鉛錫膏回流焊接會(hui) 出現持續的Cu6n5生長。隨著回流時間(熔點之上)的增加到50s,焊點開始出現Cu3Sn層並且不斷的長大,並且後續都出現不同程度的空洞(紅色圓圈)。金屬間化合物生成的機製主要是金屬成分擴散和界麵反應。在回流過程中,Cu向焊料的溶解並發生界麵反應。由於(yu) 高生長速率,Cu6Sn5晶粒呈不規則扇形生長。隨著回流時間的增加和Cu原子沿晶界擴散,Cu6Sn5晶粒不斷生長。Cu6Sn5又會(hui) 和Cu反應生成Cu3Sn。焊料層中的Ag3Sn對可靠性基本沒有影響,反而其微小顆粒能夠起到細化晶粒的作用並增強可靠性。
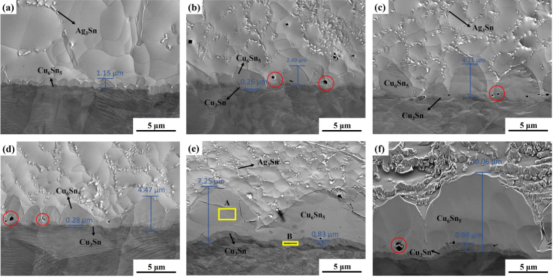
圖1. 無鉛焊點金屬化合物層的變化。回流時間: (a)5s, (b)50s, (c)80s, (d)120s, (e)900s, (f)1800s。
如圖2所示,當回流時間(熔點之上)控製在50-120秒的時候,SAC305焊點的剪切強度較高。盡管回流時間為(wei) 180s的時候剪切強度略有上升,但隨著回流時間進一步增加,強度斷崖式下跌。因此,SAC305錫膏推薦的回流時間大致在50-120秒左右。SnZn9Bi2.5In1.5錫膏具有比SAC305錫膏更優(you) 秀的剪切強度,但是仍未普及使用,僅(jin) 作為(wei) 對照組。

圖2. 剪切強度對比。
ac米兰官方网站是一家全球領先的微電子與(yu) 半導體(ti) 封裝材料方案提供商。福英達中溫錫膏SAC305等產(chan) 品潤濕效果好,粉末顆粒均勻,焊後可靠性強。歡迎進入官網了解更多信息。
參考文獻
Gong, S.L., Chen, G.Q., Qu, S.T., Ren, A.S., Duk, V., Shi, Q.Y. & Zhang, G. (2021). “Shear strength and fracture analysis of Sn-9Zn-2.5Bi-1.5In and Sn-3.0Ag-0.5Cu pastes with Cu-substrate joints under different reflow times”, Microelectronics Reliability, vol.127.







 返回列表
返回列表



