無鉛錫膏的基礎知識百科 (5)_福英達焊錫膏


無鉛錫膏的基礎知識百科 (5)_福英達焊錫膏
回流焊後焊點缺陷有很多種類,例如柯肯達爾空洞,熱蠕變和電遷移。隨著電子元器件小型化發展,焊點尺寸日趨微型化,焊接的缺陷導致空洞麵積越來越大。柯肯達爾空洞對焊點的可靠性帶來巨大的挑戰。同時隨著電子技術發展,焊點需要麵對各種複雜服役溫度場景。在高溫作用下會(hui) 在焊點生成熱應力並導致焊點變形。此外電遷移會(hui) 發生在電流密度大元器件中。
1. 柯肯達爾空洞
1.1成因
柯肯達爾效應是一種無鉛錫膏焊接時常見的且會(hui) 影響焊點可靠性的效應。柯肯達爾空洞的形成主要是由取代固溶體(ti) 化學成分的本征擴散率差異(非互易擴散)引起的。在熱老化過程中,焊點金屬間化合物層由於(yu) 溫度影響會(hui) 不斷生長。比如說SnAgCu無鉛錫膏製作的焊點在受熱時會(hui) 加速金屬元素擴散現象。在Cu3Sn和Cu6Sn相中,Cu是比Sn更快的擴散組分。Cu向外擴散要快於(yu) Sn向Cu擴散 (Sn和Cu之間的原子通量不平衡),因此在Cu3Sn內(nei) 部和Cu3Sn/Cu界麵會(hui) 留下空位。空位不斷積聚最終會(hui) 發展為(wei) 柯肯達爾空洞。
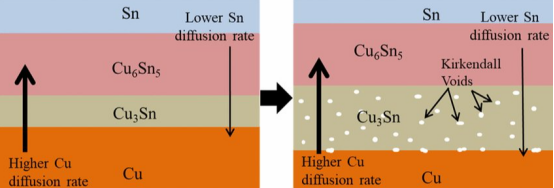
圖1. 柯肯達爾空洞形成示意圖。
1.2空洞影響及解決(jue) 方法
不同金屬間化合物相對應的熱膨脹係數不同會(hui) 造成內(nei) 部應力。在受到應力作用下,焊點空洞附近會(hui) 逐漸形成微裂紋。隨著應力作用的疊加裂紋進一步擴展,最終導致脆性斷裂。由於(yu) 空洞的出現會(hui) 導致焊點機械可靠性降低, 因此空洞率需要控製在10%以內(nei) 。業(ye) 界目前對於(yu) 抑製空洞生成主要采用添加摻雜物質的方法。例如往無鉛錫膏中加入鎳來起到抑製空洞的效果。鎳的加入使Cu3Sn層變薄。對於(yu) 電鍍銅基板,添加少量鎳減少了空洞的數量。
2. 無鉛錫膏熱蠕變現象
2.1 成因
在高溫作用下形成的熱應力作用於(yu) 元器件和焊點會(hui) 導致熱蠕變。焊點在使用過程中會(hui) 不斷地受到熱循環的影響。由於(yu) 電子器件, 基板和無鉛錫膏焊點的熱膨脹係數不匹配,不可避免地造成應力。隨著溫度升高,原子擴散速度加快,位錯開始移動,導致晶界滑移,從(cong) 而使焊點出現塑性變形。
2.2 熱蠕變影響及解決(jue) 方法
隨著老化時間增加,焊點處的應變力會(hui) 增加。當工作溫度提高且載荷保持固定時,焊點會(hui) 很快的變形並斷裂。類似的,在低溫環境和高載荷作用下,焊點依舊會(hui) 變形並斷裂。有研究發現往無鉛錫膏中加入少量摻雜物例如Bi和Ni,可使錫銀銅無鉛錫膏位錯移動減少,起到提高抗熱蠕變作用。

圖2. 不同溫度下應變力和時間的關(guan) 係。
3. 無鉛錫膏電遷移
電子產(chan) 品封裝密度和互連數增長的非常快,這大大增加了電流密度。而電流密度是電遷移現象的主要誘因。電遷移是在高電流密度下由於(yu) 電子和金屬原子之間的動量轉移而引起的物質遷移。電流密度增加會(hui) 使元器件內(nei) 部的生成焦耳熱。溫度隨之上升並加速物質擴散和造成陰極側(ce) 空洞生成,最終造成焊點開路問題。
ac米兰官方网站是一家全球領先的微電子與(yu) 半導體(ti) 封裝材料方案提供商。福英達錫膏,錫膠等產(chan) 品潤濕效果好,粉末顆粒均勻,焊後可靠性強。歡迎進入官網了解更多信息。








 返回列表
返回列表



