常見PCB焊錫性檢驗方法-深圳市福英達


常見PCB焊錫性檢驗方法
PCB焊錫性檢驗方法是指用一定的方法和標準來評價(jia) PCB上的焊盤或元件的焊錫性能,即焊錫與(yu) 被焊物之間的潤濕性和界麵反應性。國際標準J-STD-003明確規定PCB出貨前需檢驗其焊錫性。
焊錫性是影響PCB可靠性和質量的重要因素,如果焊錫性差,會(hui) 導致焊點不牢固、不完整、不均勻,甚至出現虛焊、斷路等缺陷。因此,對PCB進行焊錫性檢驗是必要的,可以及時發現和解決(jue) 問題,提高PCB的製造水平和使用壽命。
常見的焊錫性檢驗方法有:
焊錫平衡實驗法
這種方法通過測量焊錫對元件引線或焊盤的潤濕力來評價(jia) 焊錫性。潤濕力是指焊錫與(yu) 被焊物之間的粘附力,它反映了焊錫與(yu) 被焊物之間的界麵反應程度。潤濕力越大,表明焊錫性越好。潤濕力可以用一個(ge) 儀(yi) 器來測量,稱為(wei) 潤濕平衡儀(yi) 。潤濕平衡儀(yi) 可以繪製出潤濕曲線,顯示潤濕力隨時間的變化。潤濕曲線的形狀和麵積可以用來判斷焊錫性的好壞。

漂錫實驗法
將待測PCB浸入助焊劑槽內(nei) 30秒,撈出後以45度角放入熔融錫槽內(nei) 保持5秒鍾(注意浸錫時間內(nei) 不得在焊錫內(nei) 擺動測試樣品),撈出後觀察焊錫麵。當沾錫麵95%以上麵積均勻光滑潤濕良好,剩餘(yu) 麵積未集中出現針孔、退潤濕、表麵粗糙等缺陷,則說明焊錫性良好。
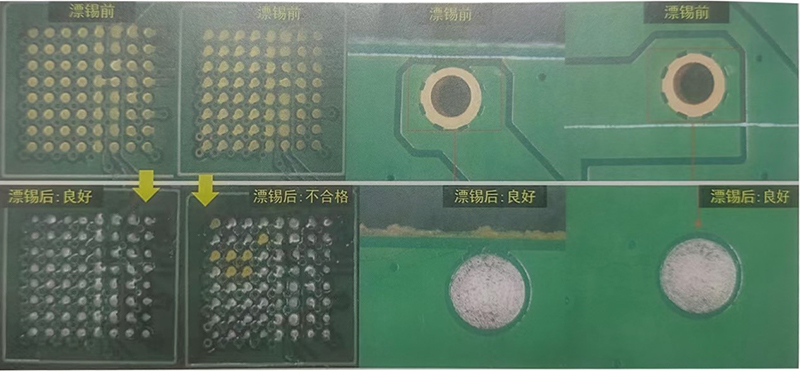
印錫實驗法
印錫實驗是另一種常用的評定PCB焊錫性的方案,因PCB製造廠一般不具備PCBA製程設備,是以多用於(yu) SMT廠評定PCB焊錫性。隨著電子產(chan) 品便攜趨勢的茁壯成長,HDI板應用成為(wei) 主流,如手機、平板電腦、筆記本電腦等便攜產(chan) 品生產(chan) 廠家已經不用波峰焊工藝許多年,工廠內(nei) 自然也無可以用來做漂錫實驗的波峰焊設備,這讓使用印錫實驗鑒定PCB焊錫性一展身手、大放異彩。
印錫實驗是使用PCB對應的SMT印刷製程鋼板正常完成錫膏印刷,直接過reflow(正常的回流焊接工藝參數)後觀察PCB焊盤焊錫潤濕狀況以判定PCB焊盤焊錫性能。HDI板焊接製程隻有T&B side兩(liang) 次熱衝(chong) 擊,考慮焊盤表麵合金化及烘烤等因素,一般要求新開PCB裸板直接過reflow一次後再做印錫實驗。印錫實驗的另一收獲是可以驗證鋼板開孔設計是否合適,以有延伸腳器件為(wei) 例,印錫實驗後焊錫均勻的平鋪在焊盤上的狀態並不是最完美的——不同液體(ti) 表麵張力不同,單位麵積能承載的該種液體(ti) 量是固定的,器件引腳需要的焊錫量在無引腳時會(hui) 堆積在焊盤上並形成錫瘤,熔化後無錫瘤的鋼板開孔設計其實是錫量不充足的表現。
印錫實驗能精確評價(jia) 實際PCB焊錫性,相對於(yu) 波峰焊漂錫實驗及錫槽漂錫實驗,工藝有點複雜,但其直接效果越來越來越多的被業(ye) 界同仁讚同及使用。
拖錫實驗法
拖錫實驗是人工使用烙鐵評估PCB焊錫性的最古老的做法,在最初手工焊接階段增為(wei) 砥柱中流。烙鐵拖錫一般焊錫充足,形成的焊點飽滿,但也因此掩蓋了PCB退潤濕的現象,不利於(yu) 測定焊點潤濕角。堆起來的焊錫遮蓋部分縮錫的現象,這情形恰似BGA焊點眾(zhong) 多錫球焊接正常,一個(ge) 球對應焊盤不上錫依然會(hui) 形成腰鼓狀焊點。這是為(wei) 何業(ye) 界評估一個(ge) 焊點看潤濕角而不是看錫量的原因,也是國際一流車企不接受手工焊接的原因之一。另一影響手工拖焊的因素是烙鐵溫度較高、錫絲(si) 助焊劑含量較高,這使得正常的reflow&波峰焊工藝焊接不良者在拖焊時仍有機會(hui) 被焊錫覆蓋導致誤判PCB焊錫性。隨著業(ye) 界工藝的演進與(yu) 產(chan) 品可靠性要求的提升,手工拖焊逐漸走進曆史而被塵封。







 返回列表
返回列表



