焊接時出現空洞的成因和緩解措施-深圳福英達


焊接時出現空洞的成因和緩解措施-深圳福英達
瞬態液相(TLP)鍵合是一種在高溫電子器件,特別是功率器件封裝中較為(wei) 常見的鍵合技術。TLP鍵合可以在較低的溫度進行,且能在較高的溫度下保持穩定。TLP鍵合使用低熔點金屬作為(wei) 中間層,並與(yu) 基板上的高熔點金屬結合。然而,該技術會(hui) 明顯受到焊接空洞的影響,這會(hui) 導致焊點熱傳(chuan) 遞能力和機械強度下降。空洞是TLP鍵合需要重點關(guan) 注的問題。
1.1 體(ti) 積收縮
TLP係統中形成空洞的常見原因是體(ti) 積收縮。當焊點內(nei) 部開始形成IMCs時,由於(yu) IMC與(yu) 原始焊料金屬的結構和數量密度不同,因此,在平衡條件下, IMCs的體(ti) 積將需要比初始反應元素的體(ti) 積總和更小。由於(yu) IMC體(ti) 積的收縮和焊點厚度的減小,焊點內(nei) 部會(hui) 產(chan) 生拉伸應力,而應力的釋放往往會(hui) 造成空洞。
1.2 形成IMCs的液相不足
TLP鍵合時形成IMC的液相量不足會(hui) 導致焊點形成空洞。如圖1所示,當Sn層厚度略大於(yu) η-Cu6Sn5時,隨著加熱的進行,剩餘(yu) 的Sn熔化,但隨後與(yu) Cu的反應受到η相固體(ti) 晶粒的限製。在受限區域中Sn和Cu的反應造成了焊料本體(ti) 消耗,導致空洞的形成。
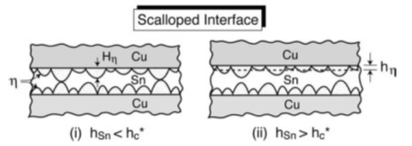
圖1. Sn-Cu係統的IMC生長。
1.3 柯肯達爾空洞
焊料和焊盤之間界麵處IMCs內(nei) 的不同互擴散率導致了部分區域焊料的消耗從(cong) 而形成柯肯達爾空洞。通常TLP焊點中柯肯達爾空洞的形成也是由不同金屬成分在焊料/基板界麵的不平衡擴散引起。柯肯達爾空洞形成一般發生在Sn-Cu TLP係統中,這是因為(wei) Cu向外擴散速度較快,在Cu3Sn IMC中留下了空洞。
2.1 引入緩衝(chong) 層
在TLP係統中的反應層之間引入金屬層能形成額外的IMC,該IMC可以彌補被消耗的低溫液體(ti) 。例如,為(wei) 了防止在Ni3Sn4 IMCs內(nei) 形成空洞,可以采用Sn2.4Ag代替純Sn。隨著老化時間增加,Ag3Sn大量出現在Ni3Sn4層之間,且未發現有空洞的出現。
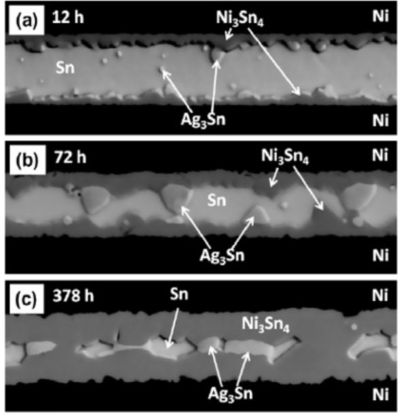
圖2. 180℃老化過程中Ni/Sn2.4Ag/Ni 焊點演變。(a) 12h; (b)72h; (c)378h。
2.2 優(you) 化鍵合溫度
由於(yu) 原子擴散速度一般與(yu) 溫度成正比,因此當鍵合溫度過高時,Cu等原子快速的擴散會(hui) 造成更多的空洞形成。此外,如果焊接加熱速度太慢,中間層反應會(hui) 不斷與(yu) 基板金屬反應並完全消耗。在這種情況下,中間層難以進入熔化階段導致不能填充焊點中的間隙,從(cong) 而在最終焊點中留下空洞。
福英達有著紮實的錫膏開發和生產(chan) 經驗,且有著大量專(zhuan) 業(ye) 的研發設備,因此可以為(wei) 客戶提供優(you) 質的不同焊接溫度的米兰体育登录入口官网。此外,福英達能為(wei) 客戶優(you) 化回流曲線和提供焊接工藝改善建議。歡迎客戶與(yu) 我們(men) 合作。
Mokhtari, O. (2019). A review: Formation of voids in solder joint during the transient liquid phase bonding process - Causes and solutions. Microelectronics Reliability, vol.98, pp.95-105.







 返回列表
返回列表



