錫膏微凸點幾何形狀


https://www.fotric222.com/
錫膏微凸點幾何形狀
隨著封裝工藝的發展,為(wei) 了滿足更高的封裝要求,越來越多廠家開始使用BGA工藝。BGA工藝能夠通過將錫膏印刷在焊盤上,從(cong) 而回流後形成微凸點。隨後可將元件與(yu) 凸點進行焊接。印刷錫膏的工藝需要得到精密的控製,因為(wei) 凸點的幾何結構對焊點的可靠性有很大的影響。表麵張力,錫膏焊盤接觸角和密度通常是影響焊料凸點幾何形狀的材料特征的關(guan) 鍵因素。因此,為(wei) 了應對半導體(ti) 技術中的微架構設計,需要更好地了解焊料凸點的幾何形狀。
凸點結構可以用來應對各種尺寸的封裝要求,錫膏凸點的表麵張力,焊料焊盤接觸角和密度決(jue) 定了可達到的最小凸點表麵積。Yusof et al. (2022) 使用不同種類錫膏進行凸點製作並觀察幾何結構(圖1)。由圖2可知,目前主流凸點工藝中,標準倒裝凸點尺寸最大,而細間距銅柱凸點最小。
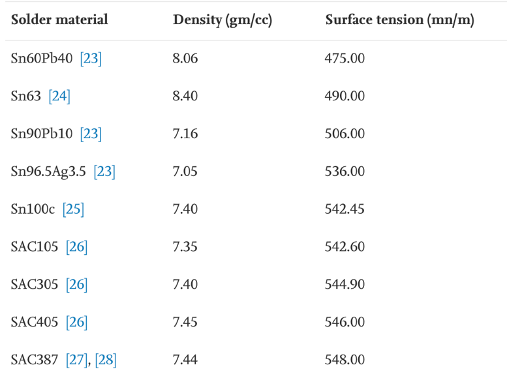
圖1. 錫膏材料的密度和表麵張力參數(Yusof et al., 2022)。

圖2. 不同凸點形式的標準和要求 (Yusof et al., 2022)。
根據Yusof et al.的模擬結果,錫膏凸點平均最大寬度和平均高度與(yu) Surface Evolver軟件預測的結構的百分比差異隨錫膏量下降而上升。由於(yu) 細間距銅柱凸點的尺寸最小,得到的最大寬度和高度間的差異最大。此外,由於(yu) 實現靜態平衡力所需的總能量隨著體(ti) 積的減小而增加,因此難以用較小的凸塊尺寸實現穩定性。從(cong) 標準倒裝芯片到最小的細間距銅柱,達到平衡所需的單位初始麵積的總能量減少增加了數百倍。

圖3. 使用Surface Evolver模擬不同錫膏製成的凸點幾何結構尺寸 (Yusof et al., 2022)。
表麵張力越大,錫膏和焊盤接觸角就會(hui) 越大,因此凸點的高度會(hui) 增加。並且大張力會(hui) 縮小寬表麵積和寬度。密度的變化同樣影響高度。密度增加會(hui) 使得凸點高度變小,在回流過程中受到重力,大密度,大張力共同作用下,凸點高度寬度降低。
深圳市福英達專(zhuan) 業(ye) 生產(chan) 可用於(yu) 凸點工藝的米兰体育登录入口官网,凸點圓潤,焊接後寬高比例優(you) 秀,歡迎谘詢了解。
參考文獻
Ab Aziz bin Mohd Yusof, Mohd Al Fatihhi Mohd Szali Januddi, & Muhamad Noor Harun. (2022), “A study of micro-scale solder bump geometric shapes using minimizing energy approach for different solder materials, Ain Shams Engineering Journal”, vol.13(6).







 返回列表
返回列表



