電鍍共晶SnBi錫膏凸點的性質


https://www.fotric222.com/
電鍍共晶SnBi錫膏凸點的性質
電子封裝行業(ye) 的趨勢要求更輕、更小、更靈活的產(chan) 品。為(wei) 了實現芯片的微型化,焊盤間距變得越來越小。此外為(wei) 了充分利用芯片空間,越來越多廠家采用倒裝封裝工藝,這種工藝能夠產(chan) 生更多的I/O接口數量,更好的電氣性能和更小的封裝體(ti) 積。研究者發現使用電鍍錫膏製作凸點可以滿足倒裝封裝的要求。電鍍錫膏工藝能夠解決(jue) 成本問題,規模生產(chan) 問題和滿足細間距要求。共晶錫鉍錫膏是適用於(yu) 製作微凸點的焊料,熔點低且機械性能良好。
倒裝芯片需要在凸點下製作金屬層。然後在焊盤上沉積錫膏並回流成為(wei) 焊點。采用商業(ye) 電鍍直流脈衝(chong) 電鍍裝置能夠將共晶Sn-Bi錫膏電鍍到焊盤上。 Roh et al. (2014) 進行電鍍共晶SnBi錫膏實驗並測試焊點可靠性。恒定的電位和電流密度是穩定電鍍的關(guan) 鍵。以30 mA/cm2電鍍15分鍾可製成柱狀 Sn-Bi 凸點,平均凸塊直徑和高度為(wei) 分別為(wei) 22 ± 0.4和18 ± 06 lm (Roh et al., 2014)。
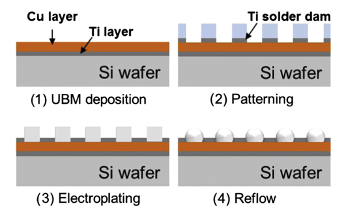
圖1. 電鍍SnBi錫膏凸點流程示意圖 (Roh et al., 2014)。
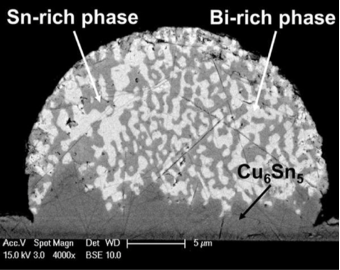
圖2. 170℃回流20分鍾後的焊點橫截麵圖 (Roh et al., 2014)。
在170℃回流20分鍾後, 錫膏潤濕焊盤並形成半球形焊點。圖2白色部分是富鉍相而灰色的是富錫相。同時可以觀察到焊點出現金屬間化合物Cu6Sn5生長。Cu6Sn5的生長是和回流時間有關(guan) 係的。回流時間越長則會(hui) 導致更多的Cu6Sn5。其他IMCs例如Cu3Sn並不會(hui) 在回流中生成。通常來說Cu3Sn在老化測試中會(hui) 逐漸出現,並隨著老化時間增加而增加。
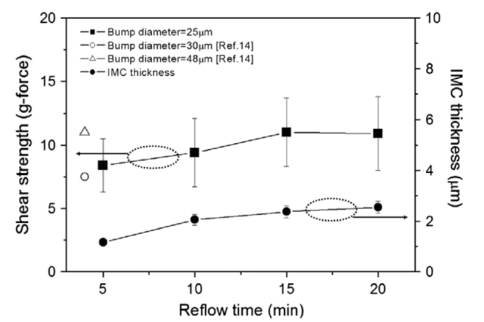
圖3. 回流時間和剪切強度的關(guan) 係 (Roh et al., 2014)。
由圖3可以看到,隨著回流時間增加,電鍍共晶SnBi凸點剪切強度增加。但是不能過長的回流,否則由於(yu) IMC的過度生長,焊點會(hui) 變得脆性並導致斷裂。脆性斷裂還發生在熱老化中。隨著老化時間增加,脆性IMC自發生長並最終導致脆性斷裂。目前很多實驗結論表麵,摻雜納米金屬顆粒能夠改善脆性斷裂問題。共晶SnBi凸點的硬度較低,可根據實際需要應用在特定元器件上。
深圳市福英達是致力於(yu) 生產(chan) 高可靠性錫膏的廠家,產(chan) 品涵蓋各種合金組合,例如錫鉍和錫銀銅等,歡迎進一步了解。
參考文獻
Roh, M.H., Jung, J.P., & Kim, W.J. (2014), “Microstructure, shear strength, and nanoindentation property of electroplated Sn–Bi micro-bumps”, Microelectronics Reliability, 54, pp. 265-271.







 返回列表
返回列表



