中溫焊料_BGA焊點的熱斷裂失效機製


中溫焊料: BGA焊點的熱斷裂失效機製
BGA的出現是為(wei) 了滿足增加集成電路的I/O接口數量的需求,已經在高密度封裝大量采用。與(yu) 傳(chuan) 統微電子封裝技術相比,BGA是使用合金焊料球代替引腳來完成信號傳(chuan) 輸,降低了電信號的傳(chuan) 輸損耗。但是高密度的集成也帶來了更高的服役溫度,對BGA的熱老化可靠性帶來了挑戰。在高溫作用下,焊點內(nei) 部會(hui) 持續產(chan) 生熱應力,導致疲勞累積,最終可能導致焊點斷裂。
眾(zhong) 所周知IMC的出現是無鉛錫膏焊接難以避免的。由於(yu) IMC在老化過程的生長是決(jue) 定焊點可靠性的關(guan) 鍵因素,因此需要了解熱疲勞過程中的焊點微觀結構變化,從(cong) 而推斷出IMC對BGA焊點可靠的影響。如圖1所示,Li等人采用中溫焊料SAC305 BGA完成與(yu) Sn63Pb36錫膏層和Sn62Pb36Ag2錫膏層的裝配,並進行熱循環測試(-55℃-125℃)。中溫焊料SAC305 BGA的頂部與(yu) 芯片的Ni焊盤連接,底部與(yu) PCB的Cu焊盤連接。

圖1. BGA焊點示意圖。
BGA焊點老化測試結果
如圖2所示。無鉛焊料SAC305 BGA中的灰色相為(wei) Sn,白色相為(wei) Pb。在剛完成焊接時焊點結構精細。在600次熱循環後,Pb進一步擴散到了BGA中,並且Pb晶粒開始粗化。此外,在完成1200次熱循環後,在BGA-芯片一側(ce) 和BGA-PCB一側(ce) 都可以清楚地看到由Pb晶粒進一步粗化並積聚形成網絡結構。
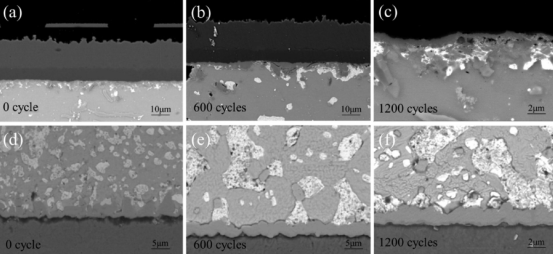
圖2. BGA焊點老化測試。(a-c)BGA-芯片一側(ce) ; (d-f)BGA-PCB界麵一側(ce) 。
在熱循環3200次後,BGA-芯片一側(ce) 大致分為(wei) 了Ni區,IMC(Cu,Ni)6Sn5區,Sn區。可以觀察到Sn區出現了晶粒粗化和再結晶現象。(Cu,Ni)6Sn5區則是出現了一定程度的位錯。另外,在BGA-PCB一側(ce) 可以看到AC區和BC區的界麵出現了較長的裂紋,並沿著的晶界向外擴展(圖4),形成穿晶裂紋。這為(wei) 焊點連接處斷裂的出現帶來隱患。圖4(c)還可以看到有空洞的形成。在空洞和裂紋的共同作用下,該區域受到應力時將更容易出現斷裂。此外,BGA-PCB一側(ce) 的D區會(hui) 有晶粒錯位。

圖3. 熱循環3200次後的BGA-芯片界麵一側(ce) 的微觀結構。(b): 圖(a)的成分分布; (c): 圖(a)虛線區放大圖; (d): 圖(a)實線區放大圖。

圖4. 熱循環3200次後的BGA-PCB一側(ce) 的微觀結構。(b): 圖(a)的成分分布; (c): A區放大圖; (d): C區放大圖。
焊點斷裂分析
無鉛焊料BGA焊點,焊料層和焊盤等材料的熱膨脹係數不匹配是焊點熱老化失效的主要誘因。當元件使用過程產(chan) 生熱應力,材料的膨脹使得焊點內(nei) 部和表麵出現應力並逐漸累積。Li等表示Sn晶粒再結晶和(Cu,Ni)6Sn5的位錯能釋放部分應力。(Cu,Ni)6Sn5傾(qing) 向擴散到芯片焊盤的Ni層並形成網格結構,也可以釋放應力。可以知道的是Ni層起到抑製原子擴散的作用,減緩IMC生長,從(cong) 而減緩斷裂失效速度。而BGA-PCB界麵處沒有Ni層的阻隔,Cu6Sn5生長速度更快,在應力作用下會(hui) 出現穿晶裂紋。
深圳市福英達可生產(chan) 中溫超微米兰体育登录入口官网,能夠替代BGA焊料球用於(yu) 高密度微間距封裝。同時中溫超微米兰体育登录入口官网也可用於(yu) 製作BGA焊盤上的焊料層。歡迎與(yu) 我們(men) 聯係。
參考文獻
Li, Q.H., Zhao, W., Zhang, W., Chen, W.W. & Liu, Z.Q. (2022). “Research on Thermal Fatigue Failure Mechanism of BGA Solder Joints Based on Microstructure Evolution”. International Journal of Fatigue.







 返回列表
返回列表



