無鉛錫膏使用_微電子與半導體焊接微冶金過程


無鉛錫膏使用_微電子與(yu) 半導體(ti) 焊接微冶金過程
微電子和半導體(ti) 的封裝過程是為(wei) 了實現芯片和PCB之間的電,熱連通。通常需要使用錫膏作為(wei) 芯片和PCB間填充材料。當無鉛錫膏通過印刷,點膠或噴印等手段塗覆到母材表麵並完成元件的貼裝之後,需要采取回流工藝完成焊接工作。無鉛錫膏在回流加熱過程會(hui) 與(yu) 焊接母材發生一係列反應。例如,錫膏助焊劑成分會(hui) 改變焊接母材和錫膏合金粉末表麵的張力,使得焊料能在焊盤鋪展。同時助焊劑能還原焊盤上的氧化物。最後在加熱條件下錫膏會(hui) 與(yu) 焊盤發生冶金反應完成連接。那麽(me) 什麽(me) 是冶金連接呢?
冶金連接機理
焊點的高機械強度依賴優(you) 秀的冶金連接。冶金連接指的通過加熱手段,使無鉛錫膏和焊接母材間形成原子級的冶金結合並形成永久性焊點。冶金連接本質上是通過原子擴散來實現的。錫膏金屬原子和焊盤銅原子在加熱作用下相互擴散並消耗,在焊料和焊盤界麵形成特定金屬間化合物(IMC)。IMC隨後會(hui) 成核並生長,從(cong) 而形成焊料和焊盤間的冶金連接。IMC類型可通過金屬相圖確定。
例如,當使用SnAg3Cu0.5無鉛錫膏和Cu焊盤進行加熱焊接時,Cu原子會(hui) 進行晶界擴散至焊料和焊盤的界麵處。然後Cu原子會(hui) 溶解到焊料中,在界麵與(yu) 焊料Sn原子以特定原子比例形成連續的IMC層。由於(yu) 在回流過程中無鉛錫膏的Sn原子充足,因此主要形成的IMC是Cu6Sn5。Cu6Sn5在生長過程中會(hui) 逐漸熟化變成扇貝形狀 (圖1)。隨著時間推進,還會(hui) 生成另一種IMC叫Cu3Sn, Cu3Sn 的出現伴隨著Sn和Cu6Sn5的消耗。
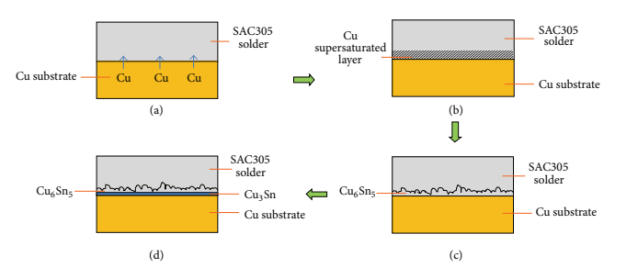
圖1. SAC305錫膏焊接IMC生長過程 (Lee 和 Mohamad, 2013)。
在回流中,除了Cu6Sn5和Cu3Sn,熔融焊料中的Sn和Ag也會(hui) 反應,從(cong) 而在焊料內(nei) 部生成少量的Ag3Sn。在無鉛錫膏固化後,Ag3Sn在IMC層附近均勻散布。Ag3Sn的生長與(yu) 焊料中的Ag含量有關(guan) 。當Ag含量在4wt%以上,會(hui) 出現大塊Ag3Sn。
錫膏量和回流時間對冶金連接的影響
冶金連接過程生成IMC種類和數量取決(jue) 於(yu) 錫膏金屬成分和錫膏量。當錫膏充足,Sn持續向Cu焊盤界麵擴散,Cu6Sn5層更厚。此外,Sn含量高會(hui) 導致回流中出現球形Cu6Sn5。
隨著回流時長增加,Sn會(hui) 逐漸消耗,Sn擴散率降低,Cu6Sn5層厚度趨於(yu) 穩定。此時Cu3Sn IMC開始緩慢生長。總IMC厚度仍會(hui) 繼續增加。通常在熱老化過程中Sn會(hui) 完全消耗,Cu6Sn5會(hui) 開始分解並在Cu焊盤一側(ce) 形成更多Cu3Sn。Cu3Sn的過度生長產(chan) 生的影響是負麵的,會(hui) 導致焊點變脆,使焊點更易發生脆性斷裂。
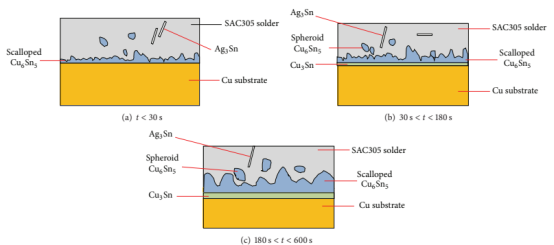
圖2. 不同回流時間SAC305-Cu焊盤界麵的IMC生長情況 (Lee 和 Mohamad, 2013)。
深圳市福英達能提供用於(yu) 回流焊接工藝的米兰体育登录入口官网,並能為(wei) 客戶提供回流曲線建議,幫助客戶控製焊接產(chan) 品IMC層厚度和改善焊點性能。
參考文獻
Lee, L.M. & Mohamad, A.A. (2013). “Interfacial Reaction of Sn-Ag-Cu Lead-Free Solder Alloy on Cu: A Review”. Advances in Materials Science and Engineering.







 返回列表
返回列表



