機械應力和熱應力下的BGA焊點可靠性-深圳市福英達


機械應力和熱應力下的BGA焊點可靠性
BGA(球柵陣列封裝)是一種常見的集成電路封裝技術,它具有接觸麵積大、信號傳(chuan) 輸效率高等優(you) 點。然而,BGA焊點位於(yu) 器件底部,不易檢測和維修,而且由於(yu) BGA功能高度集成,焊點容易受到機械應力和熱應力的影響,導致開裂或脫落,從(cong) 而影響電路的正常工作。本文將分析應力作用下BGA焊點開裂的原因,並提出相應的控製方法。
機械應力和熱應力是BGA焊點開裂的主要因素
機械應力是指物體(ti) 受到外力而變形時,在其內(nei) 部各部分之間產(chan) 生的相互作用力。BGA焊點在裝配和使用過程中,可能會(hui) 受到來自不同方向的機械應力,如振動、衝(chong) 擊、彎曲等。這些應力會(hui) 導致焊點內(nei) 部產(chan) 生裂紋,甚至斷裂。
熱應力是指物體(ti) 由於(yu) 溫度變化而產(chan) 生的脹縮變形,在外界或內(nei) 部約束的作用下,不能完全自由變形而產(chan) 生的內(nei) 部應力。在高溫作用下,焊點內(nei) 部將持續產(chan) 生熱應力,導致疲勞累積,造成焊點斷裂。

圖1. BGA焊點開裂
IMC過厚會(hui) 降低焊點可靠性
IMC是焊料與(yu) 焊盤之間形成的一種金屬化合物,它對焊點的強度和可靠性有重要影響。在無鉛工藝條件下,由於(yu) 焊接溫度比有鉛工藝更高,時間更長,因而IMC的厚度相對更厚。再加上無鉛焊料本身比較硬,使得無鉛焊點比較容易因應力而斷裂。
如果BGA原始的IMC特別厚,即超過10μm,那麽(me) ,在再流焊接時,IMC很可能發展成寬的和不連續的塊狀IMC,如圖所示。這種IMC相對於(yu) 正常IMC,其抗拉和抗剪強度會(hui) 低 20%左右,在生產(chan) 周轉和裝配過程中,容易因操作應力而斷裂。
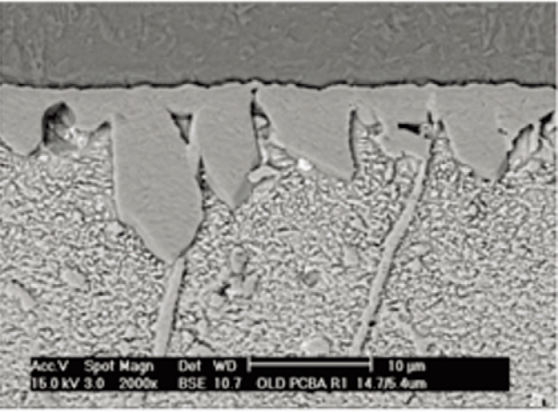
圖2. 塊狀IMC
BGA焊點開裂的控製方法
1.嚴(yan) 格管控焊接溫度和時間,避免IMC持續生長。
2.采用低Ag+Ni無鉛焊料。Ag+Ni無鉛焊料具有優(you) 良的抗機械振動性能。 Ag是加速界麵IMC生長的元素,Ni對Cu3 Sn的生產(chan) 具有抑製作用,低Ag+Ni可以有效阻止IMC生長。
3.減輕部件重量、增加機構件如散熱器的托架、增加產(chan) 品工作時剛性避免劇烈振動等,或變更生產(chan) 工藝如使用膠黏劑加固等,以此提升焊點抵抗機械應力的能力。







 返回列表
返回列表



