BGA焊點金脆化問題-深圳市福英達


BGA焊點金脆化問題
金脆化是一種焊接缺陷,指的是焊點中含有過多的金屬間化合物(IMC),導致焊點的脆性增加,可靠性降低。金脆化主要出現在BGA焊點的兩(liang) 個(ge) 位置,即BGA本體(ti) 與(yu) 錫球間和焊錫膏與(yu) 沉金板焊盤間。而BGA焊點金脆化可細分為(wei) 兩(liang) 類,一是由熱量不充足引起的金脆化,二是金含量過高引起的金脆化。
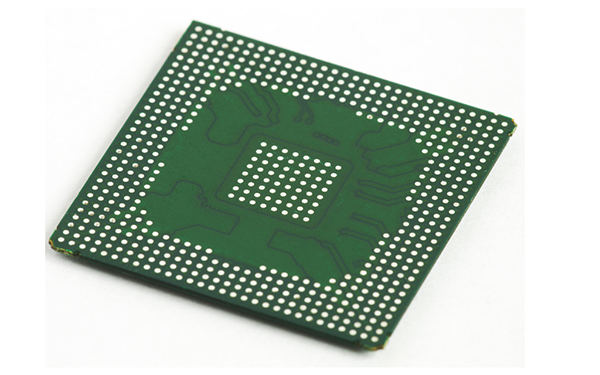
PCBA焊接過程中熱量不足,PCB沉金層的金屬會(hui) 進入液態焊錫內(nei) ,形成AuSn4堆積在焊點的金屬間化合物(IMC)附近,導致焊點產(chan) 生金脆化現象。這種金脆化問題可以通過調整PCBA的焊接工藝條件來改善,例如增加焊接溫度和延長焊接時間,確保焊點內(nei) 的金屬能夠充分熔化和擴散。
金含量過高引起的金脆化
另一類金脆化問題是由BGA焊點內(nei) 金含量超過一定比例引起的。當焊點內(nei) 金含量超過3%wt甚至5%wt以上時,金屬間化合物的形成速率增加,導致焊點金脆化。這種金脆化無法通過調整reflow焊接溫度曲線來解決(jue) ,而是需要采取其他措施。為(wei) 降低焊點內(nei) 金含量,可以控製金層的厚度或增加焊錫量,使得焊點內(nei) 的金含量維持在合適的範圍內(nei) 。
就PCBA工藝來講,化學鎳金厚度有限,不至於(yu) 導致焊點內(nei) 金含量超標,更多時候是金層擴散不完全導致的金脆化。如果金層擴散不完整,即使化學鎳金厚度合適,仍有可能出現金脆化問題。因此,對於(yu) PCBA工藝,確保金層的擴散均勻和完整也至關(guan) 重要。
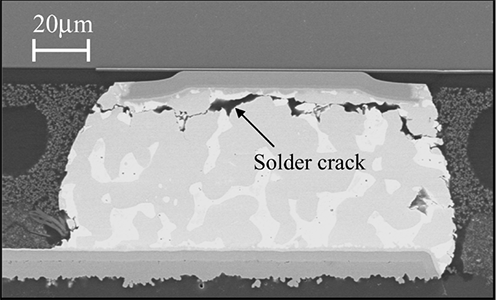
總之,BGA焊點金脆化問題是一項需要認真對待的焊接缺陷,它對電子產(chan) 品的可靠性和性能產(chan) 生不可忽視的影響。我們(men) 必須認識到,金脆化主要涉及兩(liang) 個(ge) 方麵:熱量不充足和金含量過高。解決(jue) 這些問題需要采取綜合措施,包括優(you) 化焊接工藝參數、控製金層厚度以及適當調整焊接溫度和時間。
在實際生產(chan) 中,廠商應嚴(yan) 格控製焊接工藝,確保焊接溫度和時間能夠使焊點內(nei) 的金屬充分熔化和擴散,避免金脆化的產(chan) 生。此外,對於(yu) BGA封裝設計,合理設置焊點的布局和結構,避免焊點受應力集中,也是減少金脆化的關(guan) 鍵。
同時,科學合理地選擇PCBA材料和工藝,控製金層的擴散均勻和完整,將是解決(jue) 金脆化問題的重要方向。對於(yu) 焊點內(nei) 金含量過高的情況,可以通過控製金層厚度和增加焊錫量等方式,維持金含量在合適範圍內(nei) ,從(cong) 而降低金脆化的風險。







 返回列表
返回列表



