使用溫度對金錫焊點的影響-深圳福英達


使用溫度對金錫焊點的影響-深圳福英達
在最近幾十年對可靠的高溫電子設備的需求迅速增長,主要集中在航空航天,功率電器,軍(jun) 工設備等應用。這些高溫電子設備的使用對焊點的強度和穩定性的有著極高的要求。碳化矽(SiC)是一種適應高溫的材料,通常被認為(wei) 是首選的高溫應用半導體(ti) 。Au-Sn固液互擴散(SLID)是一種能用於(yu) 高溫鍵合的技術。該技術往往會(hui) 用到共晶金錫錫膏,金錫錫膏能夠將芯片與(yu) 基板在280℃或更高的溫度鍵合且焊點可靠性高。然而電子設備的使用溫度通常會(hui) 對焊點帶來不同影響,因此金錫焊點的強度也需要進一步觀察。
Tollefsen等人在室溫,100°C,200°C和300°C下對四個(ge) Au-Sn SLID樣本組進行剪切力測試,每個(ge) 樣本組包含六個(ge) 樣本。剪切力測試條件是在基板上方施加110μm測試高度和10μm/s的測試速度。
圖1顯示了芯片剪切強度和使用溫度的關(guan) 係。從(cong) 圖中可以看出剪切強度與(yu) 使用溫度呈現負相關(guan) 關(guan) 係。當使用溫度在100℃以下時,芯片剪切強度隨溫度升高下降幅度較小,從(cong) 約140 MPa下降到約130 MPa。這是由於(yu) 增加的熱能會(hui) 在一定程度上降低化學結合能並導致芯片焊點出現熱軟化。然而,當使用溫度從(cong) 100°C上升到200°C,芯片剪切強度顯著降低至60 MPa左右。在300°C時剪切強度繼續下降,降至20 MPa左右,低於(yu) 室溫下剪切強度的15%。

圖1. 不同使用溫度下Au-Sn SLID樣品的芯片剪切強度。
下圖顯示了在室溫和300°C下剪切測試的Au-Sn SLID樣品斷裂表麵。可以發現隨著溫度的升高,斷裂模式由粘結型Au/Ni和內(nei) 聚型ζ相/SiC斷裂轉變為(wei) 以內(nei) 聚型ζ相斷裂為(wei) 主。這表明剪切強度的大幅度降低源於(yu) Au-Sn-SLID鍵的弱化。
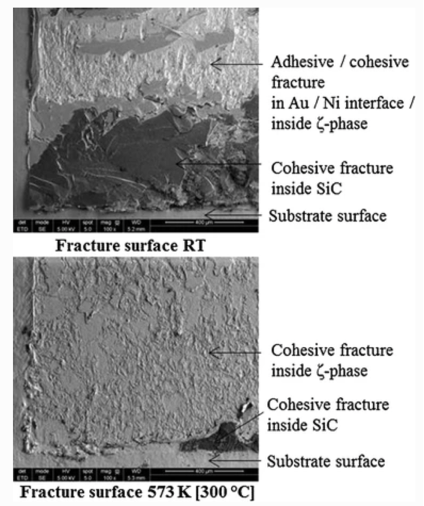
圖2. 室溫和300℃下Au-Sn SLID樣品的斷裂表麵。
深圳市福英達有著專(zhuan) 業(ye) 的高溫錫膏研發和生產(chan) 經驗,能夠為(wei) 客戶提供優(you) 質的金錫錫膏用於(yu) 高溫焊接需求。福英達金錫錫膏有著粘度穩定,殘留物少,焊點強度高等優(you) 點,歡迎客戶與(yu) 我們(men) 進行深入合作。
Tollefsen, T.A., Løvvik, O.M., Aasmundtveit, K. et al. (2013). Effect of Temperature on the Die Shear Strength of a Au-Sn SLID Bond. Metall Mater Trans A 44, 2914–2916.







 返回列表
返回列表



