焊接過程中的不潤濕與反潤濕現象-福英達錫膏


焊接過程中的不潤濕與反潤濕現象
不潤濕和反潤濕現象是焊接過程中常見的缺陷,它們(men) 分別表現為(wei) 焊料與(yu) 基體(ti) 金屬之間的不完全接觸和部分潤濕後的退縮。
不潤濕指在焊接後,基體(ti) 金屬表麵形成不連續的焊料薄膜。在不潤濕的情況下,焊料並未與(yu) 基體(ti) 金屬充分接觸,因此可以清楚地觀察到未被覆蓋的基體(ti) 金屬表麵。
此現象可能由以下原因引起:
1. 基體(ti) 金屬不具備良好的可焊性特性;
2. 所使用的助焊劑可能存在活性不足或者助焊劑已經變質失效;
3. 表麵上存在油或油脂等物質,導致助焊劑和焊料無法與(yu) 基體(ti) 金屬有效接觸。
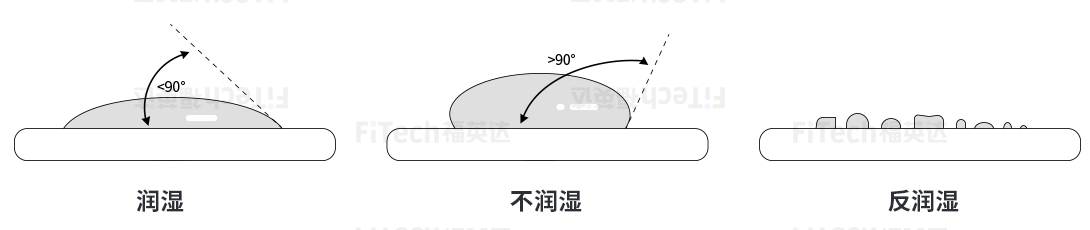
反潤濕表現為(wei) 焊料首先潤濕了基體(ti) 金屬表麵,但由於(yu) 潤濕不良,焊料發生收縮,形成薄膜,並且在基體(ti) 金屬表麵上形成分離的焊料球。
此現象的成因包括:
1. 基體(ti) 金屬表麵受到某種形式的玷汙,導致焊料部分潤濕;
2. 焊料槽中的金屬雜質含量達到一定水平,引起焊料反潤濕;
3. 焊接溫度過高或時間過長,界麵形成的合金層過厚,由於(yu) 合金層潤濕性差,導致原已潤濕的表麵上的釺料回縮,僅(jin) 留下一薄層曾潤濕過的痕跡而形成反潤濕。
1. 改善基體(ti) 金屬的可焊性,通過材料選擇或表麵處理來提升金屬與(yu) 焊料之間的親(qin) 和力。
2. 選擇活性強的助焊劑,確保其能夠有效地協助焊料潤濕基體(ti) 金屬。
3. 合理調整焊接溫度和時間,確保焊料能夠在適當的條件下充分潤濕金屬表麵。
4. 在焊接前,務必徹底清除基體(ti) 金屬表麵的油、油脂和有機汙染物,以保證良好的接觸。
深圳市福英達專(zhuan) 注於(yu) 半導體(ti) 封裝錫膏焊料的研發和生產(chan) ,錫膏產(chan) 品球形度高,潤濕性好,粒度分布窄,粒徑覆蓋T2-T10,適合各種封裝需求。歡迎來電谘詢。







 返回列表
返回列表



