SnAgCu焊料中Cu含量對起翹的影響-福英達錫膏


SnAgCu焊料中Cu含量對起翹的影響
起翹是指在製造或焊接過程中,通常是在電子元件製造和組裝中,材料或組件出現彎曲或翹曲的現象。這種彎曲通常發生在板狀或薄膜狀材料上,如印刷電路板(PCB)、芯片、電子封裝、塑料零件等。起翹可能會(hui) 導致組件不符合規格,極端情況下會(hui) 損壞組件或導致電子設備的性能問題。起翹通常是由於(yu) 不均勻的溫度分布、應力分布或材料性質差異等因素引起的。例如,在焊接過程中,不同材料的熱膨脹係數不同,可能會(hui) 導致組件在冷卻後產(chan) 生變形。同樣,不均勻的冷卻過程也可能導致材料或組件彎曲。

圖1.熱膨脹係數不匹配引起的翹曲
固、液共存區是指在焊料凝固過程中,焊料中同時存在固態和液態相的區域。這個(ge) 區域的寬度受焊料成分和溫度的影響。一般來說,固、液共存區越寬,起翹的可能性越大,因為(wei) 這意味著焊料凝固的時間更長,從(cong) 而產(chan) 生更大的熱應力和內(nei) 部應力。
固、液共存區寬度的影響對起翹的發生是不可忽視的。特別是當采用SnAgCu或SnCu焊料合金進行波峰焊接時,焊料槽中的Cu含量將發生變化。即PCB上的布線和焊盤上的Cu將溶入焊料槽中,使用時間一長,焊料槽中焊料Cu的濃度不斷增大,固、液共存區的寬度將隨之發生變化。
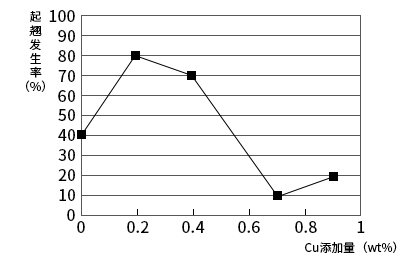
圖2.使用SnAg3.5CuX合金時Cu含量的變化對起翹發生率的影響
圖中用SnAg共晶成分,焊接引腳鍍SnPb的元器件時起翹發生的程度,當Cu含量增加到0.2wt%時,起翹的發生率達到最大。然後隨著Cu含量的增加,起翹發生率徐徐減少,當Cu含量增加到0.75wt%時起翹的發生率達到最小,然後便又緩慢地增加。顯然共晶組分能使起翹發生率最小。因此,有效管理焊料槽中的焊料成分,包括從(cong) 引腳鍍層中混入的Pb和從(cong) 基板上溶入的Cu,對於(yu) 確保焊接過程的成功至關(guan) 重要。
為(wei) 了減少或避免起翹的發生,需要控製焊料槽中的Cu含量在合適的範圍內(nei) ,一般在0.5%~1.0%之間。除此之外,還可以采用以下一些方法:
優(you) 化焊接溫度和時間,使印製板或元器件受熱均勻且充分。
優(you) 化焊接參數,使印製板或元器件受力平衡且適當。
優(you) 化印製板或元器件的設計、加工、清潔、儲(chu) 存等環節,提高印製板或元器件的品質和穩定性。
使用合適的澆口位置和形式,避免局部過熱或過冷。
使用輔助夾具或支撐物固定印製板或元器件,防止變形。
深圳市福英達生產(chan) 的錫膏產(chan) 品覆蓋多種合金,粒徑T2~T10,能夠滿足不同場景的封裝需求,歡迎來電谘詢。







 返回列表
返回列表



