環氧助焊膠在POP層疊封裝上的應用-深圳福英達


環氧助焊膠在POP層疊封裝上的應用
對於(yu) 手機等移動設備而言,BGA、CSP 或 POP 等麵積陣列封裝容易發生跌落故障,因此需要在將這些封裝組裝到印刷電路板上時對其進行加固。雖然底部填充是一種備選解決(jue) 方案,但由於(yu) 涉及額外的固化步驟,這會(hui) 增加製造成本並降低溫度循環可靠性。因此,人們(men) 更傾(qing) 向於(yu) 采用環氧助焊膠方法,這種方法省去了固化步驟的需求。
在將回流焊接陣列封裝到印刷電路板上時,環氧助焊膠用作助焊劑,然後在回流焊之後自行固化,從(cong) 而提供所需的加固效果,無需額外的固化步驟。由於(yu) 焊盤塌陷是眾(zhong) 多便攜式設備的主要故障模式,環氧助焊膠成為(wei) 了在所有聚合物加固解決(jue) 方案中,成本低廉且可靠性高的SMT組裝首選。
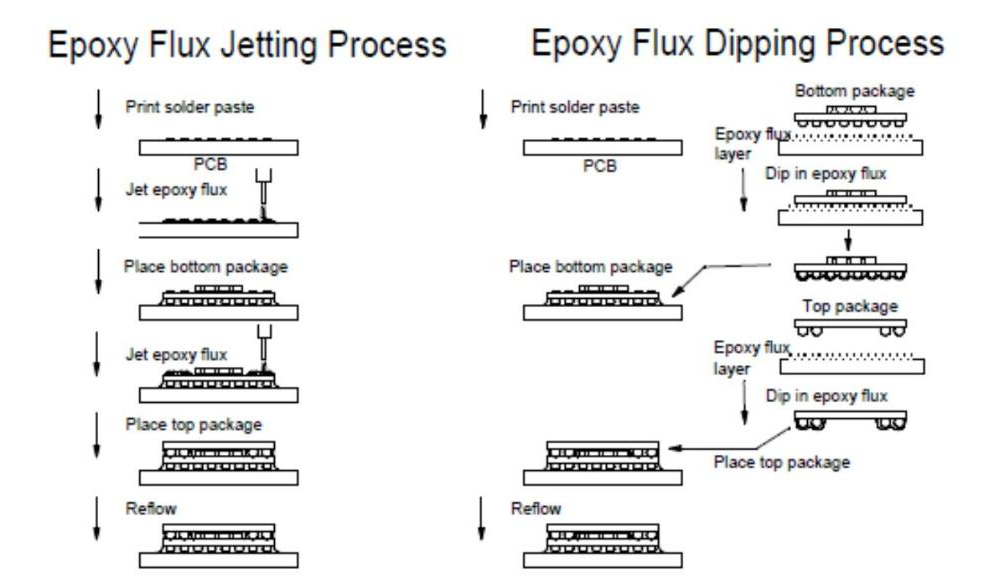
圖1.環氧助焊膠噴射和浸漬工藝
環氧助焊膠具有自組裝和自糾正功能。焊接後固化的環氧樹脂具有絕緣、防腐和可靠性增強功能,它與(yu) 底部填充膠、粘合膠等相容,提供了額外的器件保護和機械強度。環氧助焊膠可以通過浸漬或印刷方式應用到頂部元器件上,然後將它們(men) 貼裝到底部元器件上,再進行回流焊接。

圖2.POP層疊封裝
1.高精度定位:它有效防止頂部元器件在貼裝過程中的移位和傾(qing) 斜,確保元器件的準確定位。
2.減少缺陷:環氧助焊膠有效抵製頂部元器件在再流焊過程中的翹曲變形,從(cong) 而減少虛焊、開路、球窩等缺陷的產(chan) 生。
3.提高連接強度和可靠性:它增強了頂部元器件與(yu) 底部元器件之間的連接強度和可靠性,增強抗剪切、抗拉伸、抗衝(chong) 擊等性能。
4.元器件保護:環氧助焊膠有效密封單個(ge) 凸塊,防止水分、灰塵、雜質等侵入,延長元器件的使用壽命。
總之,環氧助焊膠在POP層疊封裝上的應用具有顯著的優(you) 勢,可以提高產(chan) 品的性能和質量,降低製造成本和風險。環氧助焊膠是一種新型的材料係統,值得在半導體(ti) 封裝、印刷電路板組裝乃至一些新興(xing) 的元器件工藝如疊層封裝(POP)中廣泛應用。
深圳市福英達生產(chan) 的細間距助焊膠適用於(yu) 晶圓凸點焊接、芯片蒸鍍焊接、BGA、SiP、CSP、MicroLED封裝、模組集成電路等領域的高精密、高可靠封裝。歡迎來電谘詢。







 返回列表
返回列表



