SAC305在電遷移和熱衝擊時的性能演變-深圳福英達


SAC305在電遷移和熱衝(chong) 擊時的性能演變-深圳福英達
對於(yu) 電子封裝密度越來越高的設備來說,高電流密度和微小的焊料直徑使得焊點可靠性麵臨(lin) 電遷移等問題。為(wei) 了解決(jue) 這些問題,有必要了解錫膏焊料的微觀結構演變和失效機製。並且當焊料在受到熱衝(chong) 擊時,熱量和電遷移的共同作用會(hui) 加速原子擴散和熱應力的形成,從(cong) 而導致金屬間化合物(IMC)的過度生長。另外熱衝(chong) 擊會(hui) 使得熱膨脹係數不一致會(hui) 加速焊接失效。
實驗過程
為(wei) 了深入了解焊料在熱衝(chong) 擊和電遷移時焊點會(hui) 發生哪些變化,Li等人對SAC305進行一係列的熱衝(chong) 擊(-196℃到150℃)和電遷移測試(電流密度: 2*10^4A/cm^2),並分析了焊點微觀結構演變和失效機製。圖1(a)顯示了尺寸為(wei) 20mm*20mm的測試模塊,由4個(ge) 尺寸300μm的SAC305焊球組成,焊盤直徑為(wei) 250μm,且芯片焊盤上鍍有鎳層。通過兩(liang) 個(ge) 回流工藝焊接錫球和芯片。
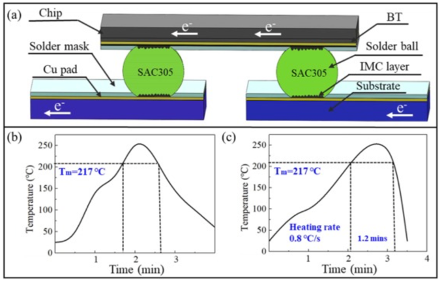
圖1. 測試單元和回流曲線。
實驗結果
IMC結構
在對SAC305焊點通電並進行熱衝(chong) 擊循環後,左側(ce) 焊點在15次熱循環後,在陽極界麵處檢測到連續的(Cu, Ni)6Sn5 IMC層,並且由於(yu) 電遷移的電子流驅動Sn和Ni原子向陽極遷移,陽極IMCs的形態從(cong) 扇貝狀變為(wei) 平麵型。在陰極界麵處也有非常薄的(Ni, Cu)3Sn4層。對於(yu) 右側(ce) 焊點,在陽極和陰極界麵分別形成了(Ni, Cu)3Sn4和Cu6Sn5。(Ni, Cu)3Sn4的厚度隨著電遷移時間增加而變厚,這歸因於(yu) 焊點原子隨著電子流從(cong) 陰極遷移到陽極。

圖2. 熱衝(chong) 擊測試後的IMC變化。
失效模式
在左側(ce) 焊點的上界麵處觀察到痕量Cu的溶解。局部痕量溶解的發生可以用SAC305焊點的凝固和電遷移後熱循環來解釋。電流傾(qing) 向於(yu) 選擇電阻最低的路徑,這也促進了電子在電子流進入焊點的位置積聚,導致在入口處產(chan) 生電流擁擠和焦耳熱。因此,由於(yu) 焦耳熱累積,在拐角處觀察到焊點的局部Cu溶解。此外,由於(yu) 不同結構的CTE不匹配和晶格畸變,裂紋沿著陰極界麵擴展導致焊點失效。類似的,右側(ce) 焊點在熱循環後也出現了Cu焊盤的局部快速溶解,並在陽極界麵處形成裂紋。
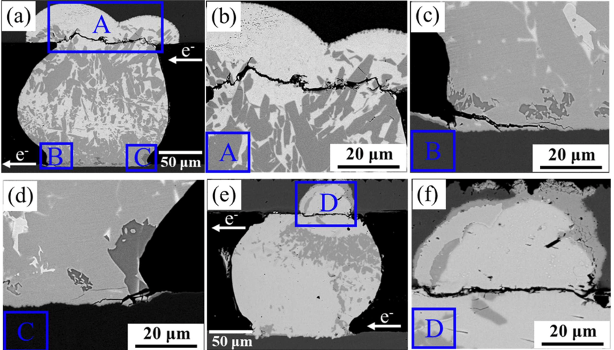
圖3. 18次熱衝(chong) 擊後焊點的失效機製。(a-d)左側(ce) 焊點; (e-f)右側(ce) 焊點
在6次熱循環之前,陰極側(ce) 剪切表麵上發現了細長的斷裂凹坑。因此,該斷裂形式屬於(yu) 韌性斷裂。在6次循環後,在剪切表麵上檢測到Ni3Sn4 IMC(紅色),這一現象表明焊點的斷裂模式轉變為(wei) 韌性-脆性混合斷裂。隨著熱循環次數繼續增加,斷裂口Ni3Sn4數量增加。陽極側(ce) 焊點也有著類似的斷裂機製,即斷裂機製從(cong) 韌性斷裂轉變為(wei) 韌性-脆性混合斷裂。通過斷裂模式可以知道陰極側(ce) 的剪切強度隨著循環次數增加而下降。然而陽極側(ce) 強度先下降後上升,這是因為(wei) 持續的極端的溫度使得斷裂麵開始出現孿晶並增強了焊點的強度。


圖4. 焊點陰極側(ce) (上)和陽極側(ce) (下)剪切失效圖。(a)回流後; (b)3次循環; (c)6次循環; (d)9次循環; (e)12次循環; (f)15次循環。
參考文獻
Li, S.L., Hang, C.J., Zhang, W., Guan, Q.L., Tang, X.J., Yu, D., Ding, Y. & Wang, X.L. (2023). Current-induced solder evolution and mechanical property of Sn-3.0Ag-0.5Cu solder joints under thermal shock condition. Journal of Alloys and Compounds.







 返回列表
返回列表



