FCCSP倒裝芯片封裝工藝介紹-深圳福英達


FCCSP倒裝芯片封裝工藝介紹
隨著移動、網絡和消費類電子設備更新換代,電子產(chan) 品的功能越來越多、體(ti) 積越來越小,對於(yu) 半導體(ti) 封裝的性能要求不斷提高。如何在更薄、更小的外形尺寸下實現更高更快的數據傳(chuan) 輸成為(wei) 了一個(ge) 關(guan) 鍵挑戰。由於(yu) 移動設備需要不斷增加封裝中的輸入/輸出(I/O)數量,封裝解決(jue) 方案正從(cong) 傳(chuan) 統的線鍵封裝向倒裝芯片互連遷移,以滿足這些要求。對於(yu) 具有多種功能和異構移動應用的複雜和高度集成的係統而言,倒裝芯片封裝(FCCSP)被認為(wei) 一種有效的解決(jue) 方案。如圖 1 所示,半導體(ti) 封裝互連技術包括引線鍵合技術和倒裝芯片鍵合技術。
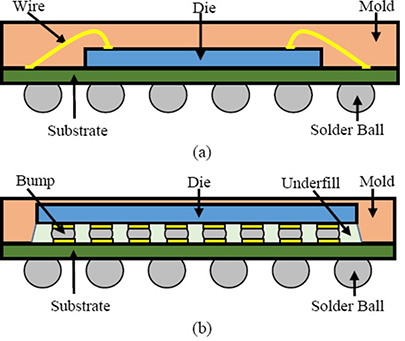
圖1. (a)引線鍵合封裝(WBCSP)、(b)倒裝芯片封裝(FCCSP)的結構示意圖
FCCSP封裝是一種先進的封裝技術,它使用倒裝芯片(Flip Chip)作為(wei) 互連方式,將芯片直接連接到層壓板或模塑基板上,通過焊點實現基板電極的互連。倒裝芯片鍵合技術由於(yu) 可以利用芯片的前表麵,因此可以比導線鍵合技術連接更多的 I/O,而且由於(yu) 芯片長度比導線長度短約 10 倍,因此具有快速信號處理的優(you) 勢。因此,倒裝芯片鍵合技術正以各種方式應用於(yu) 需要快速信號處理的高密度封裝或數字封裝的互連。
1. FCCSP封裝可以提供更高的布線密度,更低的電感,更短的信號通路,從(cong) 而優(you) 化了電氣性能,適用於(yu) 低頻和高頻應用。
2. 更小的封裝尺寸,更薄的封裝厚度,更輕的封裝重量,滿足輕薄、小型、高密度的產(chan) 品需求。
3. 采用不同的凸塊選項,如銅柱、無鉛焊料、共晶等,以適應不同的芯片和基板材料,提高了可靠性和兼容性。
4. 支持多晶片(並排堆疊)的應用,實現了更高的集成度和功能性。
5. 支持封裝內(nei) 天線(AiP)的應用,利用底部芯片貼裝(POSSUM™)技術,實現了更高的信號質量和效率。
FCCSP封裝已經廣泛應用於(yu) 移動設備(如智能手機、平板電腦等)、汽車電子(如信息娛樂(le) 、ADAS等)、消費電子(如數碼相機、遊戲機等)、通信設備(如基帶、RF等)、人工智能(如AI芯片、神經網絡等)等領域,是一種具有高性能、高可靠性、高靈活性的封裝解決(jue) 方案。
Fitech米兰app官方正版官网入口是目前全球唯一能製造全尺寸T2-T10超細合金焊錫粉的電子級封裝材料製造商,所生產(chan) 的錫粉和米兰体育登录入口官网具有良好的粘度穩定性,形狀保持和穩定性以及優(you) 良的脫模轉印性能,長時間印刷後無錫珠、橋連缺陷,適用於(yu) FCCSP、WBCSP及SiP等封裝工藝。歡迎來電谘詢。
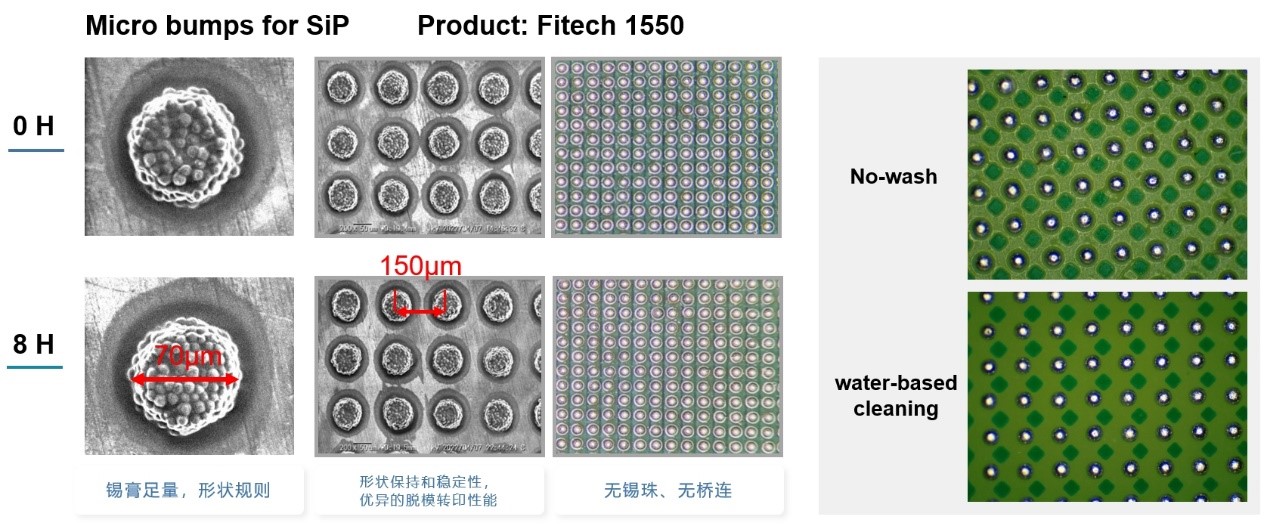







 返回列表
返回列表



