使用低溫錫鉍環氧錫膏提升封裝可靠性與效率-深圳福英達


使用低溫錫鉍環氧錫膏提升封裝可靠性與效率
低溫錫膏在電子工業(ye) 中的應用正在逐漸受到關(guan) 注,尤其是隨著集成電路元件的微型化和I/O數量的增加。傳(chuan) 統的無鉛SAC焊接回流工藝雖然普遍使用,但高溫度容易導致可靠性問題,包括工藝良率低、熱循環性能差等,這些問題往往與(yu) 翹曲有關(guan) 。
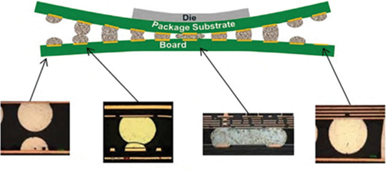
圖1. 傳(chuan) 統SAC焊料由於(yu) 焊接溫度過高易出現翹曲不良問題
低溫錫膏可有效解決(jue) 翹曲問題,業(ye) 界通常使用錫鉍合金來提高工藝良率、消除枕頭效應和提高返工良率。然而,在大多數應用中,錫鉍合金的強度通常不足以取代無鉛(SAC)和共晶錫鉛合金。為(wei) 了增強錫鉍焊點的強度、機械性能和可靠性,一種有效的方法是在錫鉍合金焊料中使用環氧樹脂代替錫膏中的鬆香樹脂,環氧樹脂膠在焊接後殘留並固化,起到補強焊點、防護和增強的作用。
環氧錫膏(錫膠)的外觀和使用工藝與(yu) 錫膏基本相同,它同樣經過印刷點膠等工藝方式在焊盤上施膠,然後在貼片對位後進行加熱焊接。在加熱過程中,合金粉末首先熔化收縮,與(yu) 焊盤形成冶金連接,隨後熱固膠發生交聯反應固化,冷卻後完成器件的封裝。

圖2.環氧錫膏與(yu) 錫膏工藝對比
環氧錫膏方案簡化了封裝工序,焊接後無需清洗和填充膠,從(cong) 而節約了封裝工藝時間和成本。該方案非常適用於(yu) 高密度微細間距,形成微凸點,有效解決(jue) 了鋼網開孔印刷的極限及巨量轉移問題。對機械可靠性要求較高的器件封裝應用也非常適用。
圖3中環氧錫膏(錫膠)焊接剪切強度(與(yu) 錫膏對比)表明,環氧錫膏焊接後的固化強度不僅(jin) 包括冶金連接力,還增加了熱固膠的膠合力。相同合金條件下,環氧錫膏的剪切強度相對於(yu) 錫膏可增加20~40%,尤其在微小器件連接方麵,這種增強作用更為(wei) 顯著。這有效解決(jue) 了低溫合金錫膏脆性和焊料“吃金”(焊料侵蝕掉鍍層)的問題。
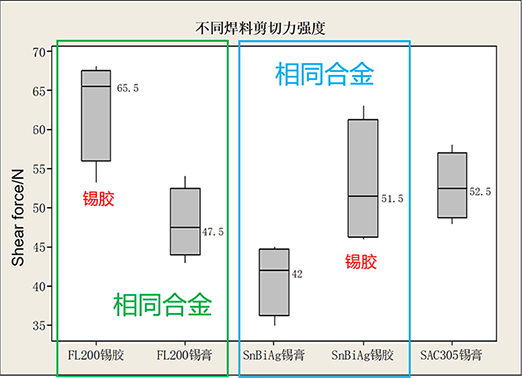
圖3.環氧錫膏(錫膠)焊接剪切強度(與(yu) 錫膏對比)
圖4錫膠表麵絕緣電阻(與(yu) 錫膏對比),根據JIS Z3197-2012標準,環氧錫膏在85℃ 85%RH、50V下經過168小時的測試,相對於(yu) 錫膏在表麵絕緣電阻方麵表現更優(you) 。這進一步證實了環氧錫膏在電子器件應用中具有更出色的性能。
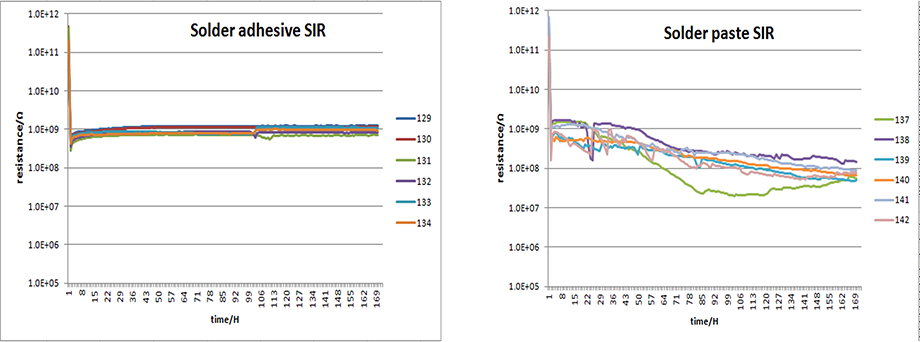
圖4.錫膠表麵絕緣電阻(與(yu) 錫膏對比)JIS Z3197-2012:85℃ 85%RH,50V,@168H
總而言之,通過采用低溫錫鉍環氧錫膏,不僅(jin) 可以提高焊接工藝的可靠性和效率,還能夠適應越來越微小化的電子元件和更高要求的機械性能,為(wei) 電子工業(ye) 的進一步發展提供了可靠的解決(jue) 方案。
深圳市福英達自主研發的環氧錫膏(錫膠)產(chan) 品包括低溫超微錫膠、中高溫超微錫膠、Mini LED 專(zhuan) 用錫膠和各向異性導電膠,歡迎來電谘詢。







 返回列表
返回列表



