利用環氧助焊劑提高倒裝芯片封裝的效率和可靠性-深圳福英達


利用環氧助焊劑提高倒裝芯片封裝的效率和可靠性
倒裝芯片組裝過程通常包括焊接、去除助焊劑殘留物和底部填充。由於(yu) 芯片不斷向微型化方向發展,倒裝芯片與(yu) 基板之間的間隙不斷減小,因此去除助焊劑殘留物的難度不斷增加。這不可避免地會(hui) 導致清洗成本增加,或影響底部填充效率及可靠性。雖然目前市麵上有使用免清洗助焊劑進行免清洗工藝,但免清洗助焊劑留下的殘留物與(yu) 底部填充化學之間的兼容性仍然是一個(ge) 主要問題。兼容性差通常會(hui) 導致毛細管底部填充流動受阻或底部填充分層。
環氧助焊劑是一種用於(yu) 倒裝芯片封裝的新型助焊劑,它的主要成分是樹脂(環氧樹脂、丙烯酸樹脂等)、有機酸活化劑、觸變劑和溶劑。在回流焊接過程中其有機組分固化成一層環氧樹脂膠,附在焊點周圍,起到加強焊點強度、防腐蝕和絕緣的作用,並防止其與(yu) 底部填充發生化學反應,同底部填充膠、邦定膠等相兼容;環氧助焊劑的固化膠可以在回流焊接過程中進行底部填充,而不需要額外的固化工藝,節省了時間和成本。
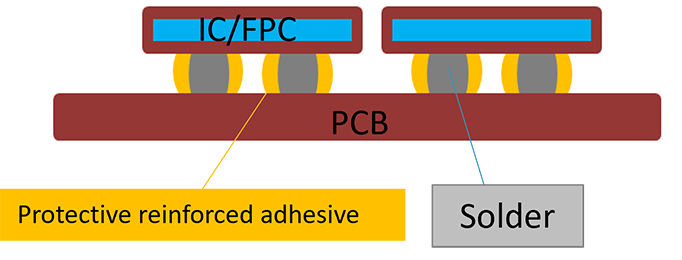
圖1. 環氧助焊劑的作用-增強和保護焊點
環氧助焊劑的特點
熱穩定性:環氧助焊劑在高溫下依然保持較好的穩定性,不易熔化或分解,適用於(yu) 高溫封裝工藝。
低揮發性:環氧助焊劑不含鹵素,具有較低的揮發性,不會(hui) 在焊接過程中釋放有害氣體(ti) ,符合環保要求。
良好的電絕緣性:由於(yu) 環氧樹脂的絕緣性能優(you) 越,助焊劑塗層不僅(jin) 能提高焊點的機械強度,還能增強焊點的電絕緣性。
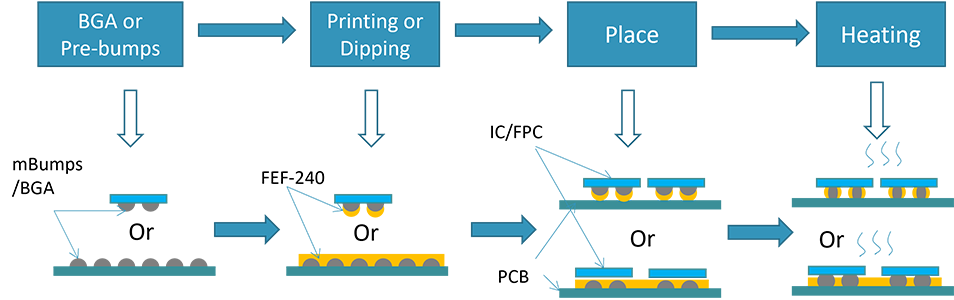
圖2. 環氧助焊劑工藝應用-BGA微凸點預置
環氧助焊劑在倒裝芯片封裝中的應用
1.表麵塗覆
在倒裝芯片封裝中,環氧助焊劑通常被塗覆在芯片的焊點區域。通過精確的印刷或浸漬工藝,確保環氧助焊劑形成均勻的保護層,提高焊點的可靠性。
2.粘結芯片和基板
環氧助焊劑的優(you) 良粘結能力使其在倒裝芯片封裝中用於(yu) 固定芯片與(yu) 基板之間的連接。這種連接不僅(jin) 具有高強度,還能在振動和溫度變化等惡劣環境下保持穩定。
3.提高封裝質量
通過環氧助焊劑的應用,倒裝芯片封裝的焊點能夠獲得更好的機械強度和電氣性能,提高封裝質量。同時,環氧助焊劑的防氧化作用確保了焊點的長期穩定性。
總而言之,環氧助焊劑在倒裝芯片封裝上的應用,可以有效地解決(jue) 傳(chuan) 統助焊劑殘留物的清洗和兼容性問題,同時提高倒裝芯片封裝的效率和可靠性,為(wei) 倒裝芯片封裝的微型化和高性能化提供了一種有效的解決(jue) 方案。如果您想了解更多關(guan) 於(yu) 環氧助焊劑的信息,歡迎隨時聯係我們(men) 。







 返回列表
返回列表



