SAC305焊料摻入少量SiC後的潤濕性怎麽樣-深圳福英達


SAC305焊料摻入少量SiC後的潤濕性怎麽(me) 樣-深圳福英達
SAC305傳(chuan) 統的錫膏在焊接的時候金屬間化合物(IMC)生長較快,容易形成較厚的IMC層並影響焊點的可靠性。可以知道SiC是一種高熔點陶瓷材料。通過在SAC305中摻入少量的微納米級SiC顆粒,在焊料熔融固化後SiC停留在焊點本體(ti) 中,從(cong) 而可以細化焊點結構並作為(wei) 金屬原子擴散的屏障,使得焊點的界麵IMC層生長速度會(hui) 明顯減緩。此外,近年來不少研究人員發現陶瓷顆粒可以改善焊料基體(ti) 的潤濕能力,從(cong) 而改善焊點微觀結構。
SAC305-SiC複合焊料
製備及潤濕性驗證
Pal等人將平均直徑為(wei) 2μm的SiC摻入SAC305焊料中,用於(yu) 合成複合焊料。SiC和SAC305粉末在高能球磨中混合約一小時。SiC和SAC305粉末在模具中單軸壓實(室溫下200Mpa冷壓)以形成直徑為(wei) 3mm的圓柱形棒。然後,將樣品放入熔爐中進行熔化製成SAC305-1.0%SiC複合焊料。

圖1. SAC305-SiC製備步驟。
Pal等人測試在230°C至290°C的不同回流溫度下,SAC305-1.0%SiC複合焊料在幹淨Cu基板上的微觀結構發展和潤濕性變化。樣品在回流下保持約60分鍾,在此期間達到潤濕性的平衡條件。
實驗結果
IMC結構
圖2顯示了在不同回流溫度下回流工藝後SAC305-1.0%SiC/Cu表麵的微觀結構。在加入1.0 wt%的SiC後,Cu6Sn5和Ag3Sn IMCs出現在Sn焊料基體(ti) 中但接近界麵附近。與(yu) Sn接觸的層是Cu6Sn5,而Cu3Sn層在Cu6Sn5和Cu之間。隨著回流溫度從(cong) 230°C升高到290°C,液/固反應中的Cu6Sn5 IMC層放緩。Cu6Sn5層隨著Cu3Sn層的生長而逐漸減小,並且Cu3Sn層隨著溫度的升高而增加。不可潤濕的SiC通常會(hui) 從(cong) 熔融焊料中轉移出來。界麵IMCs的形貌表明,在回流過程中,由於(yu) SiC顆粒的偏析而形成孔隙。
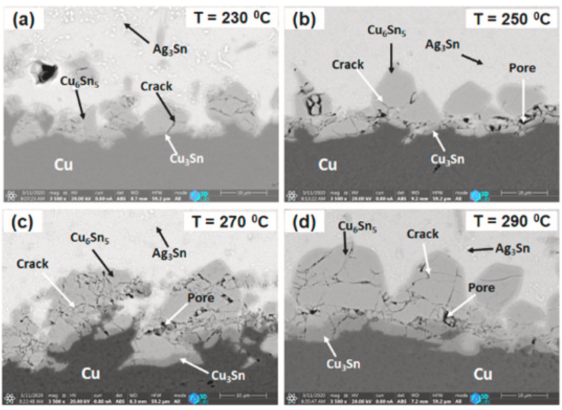
圖2. SAC305-1%SiC在不同回流溫度的IMC情況。
潤濕能力
l 當回流溫度為(wei) 270°C時,SAC305-1.0%SiC焊料的最大相對擴展麵積為(wei) 76 %,比230°C時的最大相對擴展麵積大24%左右。隨著回流溫度升到290°C,最大相對擴展反而降至68%左右。因此可以知道,焊料擴展麵積首先隨著回流溫度的增加而增加,隨著溫度進一步升高,潤濕麵積顯著減小。
圖3. SAC305-1.0%SiC潤濕麵積和回流溫度的關(guan) 係。 l 在230°C回流溫度下SAC305-1.0%SiC焊點的潤濕角較大,這表明複合焊料的潤濕性較差。隨著溫度升高,焊點的潤濕角開始下降,表麵潤濕性有所改善。當回流溫度進一步提高到290℃,潤濕角開始增大。這些結果證實,在特定的回流溫度下,可以通過增加SiC顆粒來實現焊料基體(ti) 潤濕性的改善。 表1. SAC305-1.0%SiC在不同回流溫度下的潤濕角。

參考文獻
Pal, M.K, Gergely, G., Koncz-Hoevath, D. & Gacsi, Z. (2021). Investigation of microstructure and wetting behavior of Sn–3.0Ag–0.5Cu (SAC305) lead-free solder with additions of 1.0wt%SiC on copper substrate. Intermetallics, vol.128.







 返回列表
返回列表



