實現高可靠性無鉛焊點的機械性能

米兰app官方正版官网入口-研發中心-羅樹全


焊錫的三個(ge) 基本機械特性包括應力與(yu) 應變特性、抗蠕變性和抗疲勞性。焊點剪切強度也是體(ti) 現焊點可靠性的重要因素之一,因為(wei) 多數焊點在使用期間要經受剪切應力的作用。蠕變在焊點可靠性測試中也是一個(ge) 很重要的因素,蠕變是當溫度和應力都保持常數時造成的整體(ti) 塑性變形。這個(ge) 決(jue) 定於(yu) 時間的變形可能在絕對零度之上的任何溫度發生。可是,蠕變現象隻是在“活躍”溫度時體(ti) 現出來。疲勞是指在交替應力之下,焊點可靠性下降甚至失效。疲勞破裂通常從(cong) 幾個(ge) 小裂紋開始,在應力的循環作用下增加,造成焊接點可靠性下降,元器件焊接失敗。在電子封裝和裝配應用中的焊錫通常經受低循環疲勞和遭受高應力。熱力疲勞是用來刻劃焊錫特性的另一個(ge) 測試模式。在電子封裝領域中,我們(men) 為(wei) 了確保實現高可靠性焊點,我們(men) 應該對焊點的剪切強度和拉伸強度,蠕變等情況進行測試分析。


1.1剪切強度測試
焊點的剪切強度是反應焊點可靠性的一個(ge) 重要因素,下麵是Sn3.5Ag和Sn4.0Ag0.5Cu合金分別在經過OSP工藝和鎳沉金(ENIG)工藝的焊盤上的剪切強度測試
[1]
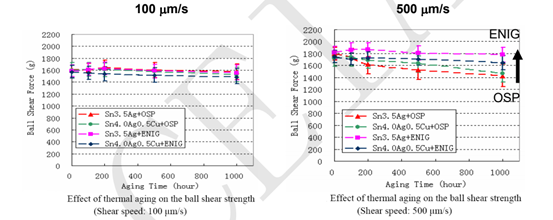
從(cong) 上圖可知,使用不同表麵處理工藝的焊盤下合金的剪切強度大小,使用ENIG表麵處理工藝≥用OSP表麵處理工藝, SAC合金和 SA合金剪切強度也是差不多;經過老化處理對剪切強度產(chan) 生負麵影響;隨著老化時間的延長其剪切強度降低。
1.2拉伸強度測試
焊點的拉伸強度是反應焊點可靠性的一個(ge) 重要因素,下麵是Sn3.5Ag和Sn4.0Ag0.5Cu合金分別在經過OSP工藝處理和鎳沉金(ENIG)工藝的焊盤上的拉伸強度測試
[2]
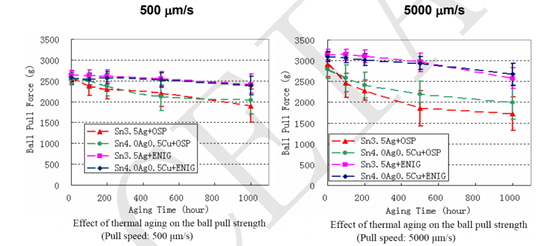
從(cong) 上圖可知,使用不同表麵處理工藝的焊盤下合金的拉伸強度大小,使用ENIG表麵處理工藝≥用OSP表麵處理工藝, SAC合金拉伸強度≥ SA合金拉伸強度;經過老化處理對拉伸強度產(chan) 生負麵影響,測試速度越快其拉伸強度老化越明顯。
1.3剪切強度和剪切速度對IMC層厚度的測試
在焊點的IMC層厚度對焊點可靠性有著重要的影響,太厚太薄都會(hui) 對焊點的穩定性和使用期限造成負麵效果。下麵是測試焊點剪切強度和剪切速度對IMC層厚度的影響情況
[3]
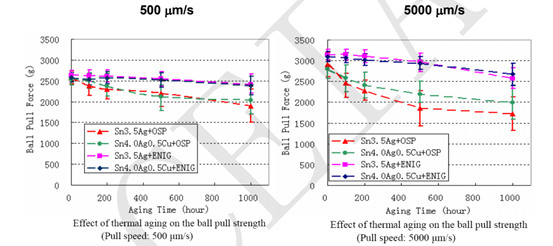
從(cong) 上圖可知,剪切強度測試中,剪切速度越快對IMC層的厚度影響越大;合金成分對IMC層的厚度影響不大。
1.4拉伸強度和拉伸速度對IMC層厚度的測試
焊點的IMC層的厚度是焊點可靠性的重要因素,下麵我們(men) 測試了拉伸強度和拉伸速度對IMC層的厚度的影響情況
[4]
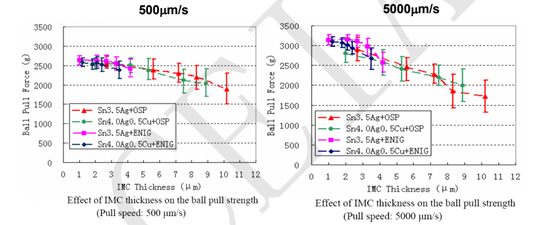
從(cong) 上圖可知,拉伸強度測試中,拉伸速度越快對IMC層的厚度影響越大;合金成分對IMC層的厚度影響不大。
1.5比較剪切強度和拉伸強度對IMC層厚度的影響大小
焊點剪切強度和拉伸強度對IMC層厚度有著重大影響,下麵我們(men) 測試兩(liang) 種不同合金和兩(liang) 種不同表麵處理工藝下剪切強度和拉伸強度對IMC層厚度影響情況
[5]
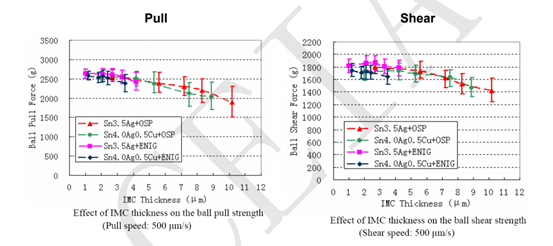
從(cong) 上圖可知,剪切強度和拉伸強度對IMC層厚度的影響大小相當。


2.1倒裝芯片接頭的蠕變數據
蠕變現象影響著焊點可靠性,下麵是倒裝芯片接頭的蠕變數據
[6][7]

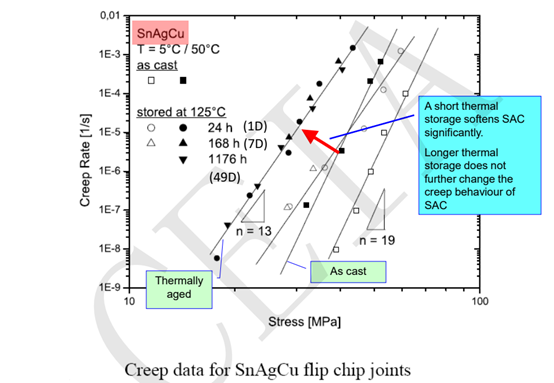
SAC合金蠕變交叉曲線和SnPb合金蠕變交叉曲線測試情況如下圖
[8]

蠕變行為(wei) 在焊點可靠性方麵起著負麵影響,下麵我們(men) 進一步分析焊點中蠕變行為(wei) 的產(chan) 生過程,焊點形變小,焊點蠕變是慢的;焊點形變大,焊點蠕變是快的。
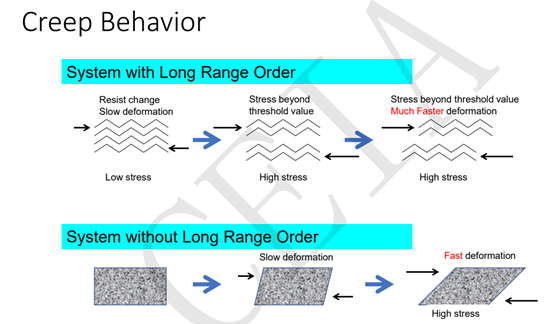
為(wei) 了焊點可靠性更好,我們(men) 應該控製合適焊點的剪切強度和拉伸強度,以及IMC層的厚度,使其達到焊接可靠性要求。電子器件在使用過程中,環境溫度會(hui) 發生變化,由於(yu) 芯片的功率循環使得周圍溫度發生變化,而芯片與(yu) 基板之間的熱膨脹係數存在差異,因此在焊點內(nei) 產(chan) 生熱應力而造成疲勞損傷(shang) 。同時相對於(yu) 環境溫度,焊料自身熔點較低,隨著時間的推移,焊點會(hui) 產(chan) 生明顯的粘性行為(wei) 而導致蠕變損傷(shang) ,造成焊點斷裂;外部失效模式則表現為(wei) 電信號傳(chuan) 輸失真,即電接觸不良、短路和斷路。
在一定的條件下,疲勞損傷(shang) 和蠕變損傷(shang) 會(hui) 產(chan) 生交互的作用,蠕變加速裂紋的形成和擴展,而循環開裂造成的損傷(shang) 又促進了蠕變的進展,這種交互作用會(hui) 加劇損傷(shang) ,使循環壽命大大縮短。而航空航天領域內(nei) 的電子產(chan) 品通常處於(yu) 更惡劣的溫度循環條件下,焊點的疲勞蠕變損傷(shang) 成為(wei) 電子產(chan) 品失效的內(nei) 在隱患。因此如何控製焊點疲勞蠕變損傷(shang) 成為(wei) 電子封裝領域一個(ge) 重要課題。
福英達專(zhuan) 注於(yu) 微電子與(yu) 半導體(ti) 封裝焊料領域20餘(yu) 年,福英達工業(ye) 科技有限公司是一家全球領先的微電子與(yu) 半導體(ti) 封裝材料方案提供商,國家高新技術企業(ye) ,深耕於(yu) 微電子與(yu) 半導體(ti) 封裝材料行業(ye) ,從(cong) 合金焊粉到應用產(chan) 品線完整,是目前全球唯一可製造T2-T10全尺寸超微合金焊粉的電子級封裝材料製造商。米兰app官方正版官网入口錫膏、錫膠及合金焊粉等產(chan) 品廣泛應用於(yu) 微電子與(yu) 半導體(ti) 封裝的各個(ge) 領域。得到全球SMT電子化學品製造商、微光電製造商和半導體(ti) 封裝測試商的普遍認可。但微電子與(yu) 半導體(ti) 封裝材料問題廣泛,在此我們(men) 僅(jin) 就常見問題展開了敘述。因工藝過程不同,其過程中所涉及到的問題也可能不盡相同。歡迎您就具體(ti) 問題與(yu) 我們(men) 的專(zhuan) 業(ye) 人員進行溝通討論。我們(men) 希望同合作夥(huo) 伴共同與(yu) 時俱進,共同探究新問題、新技術以及複雜工藝,努力為(wei) 合作夥(huo) 伴提供專(zhuan) 業(ye) 、周到的微電子與(yu) 半導體(ti) 封裝焊接材料服務。
參考文獻
[1]Fubin Song and S. W. Ricky Lee, “Investigation of IMC Thickness Effect on the Lead-free Solder Ball Attachment Strength: Comparison between Ball Shear Test and Cold Bump Pull Test Results”, 56th ECTC Proceedings, P. 1196-1203, San Diego, CA, May 30-June 2, 2006
[2]Fubin Song and S. W. Ricky Lee, “Investigation of IMC Thickness Effect on the Lead-free Solder Ball Attachment Strength: Comparison between Ball Shear Test and Cold Bump Pull Test Results”, 56th ECTC Proceedings, P. 1196-1203, San Diego, CA, May 30-June 2, 2006
[3]Fubin Song and S. W. Ricky Lee, “Investigation of IMC Thickness Effect on the Lead-free Solder Ball Attachment Strength: Comparison between Ball Shear Test and Cold Bump Pull Test Results”, 56th ECTC Proceedings, P. 1196-1203, San Diego, CA, May 30-June 2, 2006
[4]Fubin Song and S. W. Ricky Lee, “Investigation of IMC Thickness Effect on the Lead-free Solder Ball Attachment Strength: Comparison between Ball Shear Test and Cold Bump Pull Test Results”, 56th ECTC Proceedings, P. 1196-1203, San Diego, CA, May 30-June 2, 2006
[5]Fubin Song and S. W. Ricky Lee, “Investigation of IMC Thickness Effect on the Lead-free Solder Ball Attachment Strength: Comparison between Ball Shear Test and Cold Bump Pull Test Results”, 56th ECTC Proceedings, P. 1196-1203, San Diego, CA, May 30-June 2, 2006
[6]Ref: S. Wiese, M. Roellig, K.-J. Wolter, " Creep of Eutectic SnAgCu in Thermally Treated Solder Joints", 55th ECTC, P.1272-1281, May 31-June 3, 2005
[7]Ref: S. Wiese, M. Roellig, K.-J. Wolter, " Creep of Eutectic SnAgCu in Thermally Treated Solder Joints", 55th ECTC, P.1272-1281, May 31-June 3, 2005
[8]Ref: Ahmer Syed, " Accumulated Creep Strain and Energy Density Based Thermal Fatigue Life Prediction Models for SnAgCu Solder Joints", 54th ECTC, P.737-746, June 1-4, 2004, Las Vegas, Nevada.


微電子與(yu) 半導體(ti) 超微焊料方案提供商








 返回列表
返回列表



