單片機封裝(SCP)介紹-福英達錫膏


單片機封裝(SCP)介紹-福英達錫膏
單片機封裝(SCP)是一種較為(wei) 簡單且非常普遍使用的封裝模式,已經有了很豐(feng) 富的經驗。SCP通過將單個(ge) 芯片進行封裝從(cong) 而形成一個(ge) 微電子設備,往往封裝材料由低成本的塑料和高熱性能和可靠性的陶瓷製成。SCP器件從(cong) 切割晶圓開始,然後對單個(ge) 芯片進行封裝和老化測試,在結果合格後可投入生產(chan) 。
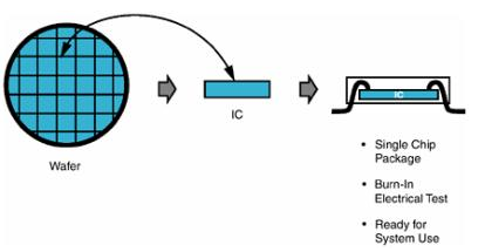
圖1. 單片機封裝基本流程。
單片機封裝方法
芯片的電信號連通需要通過邦定來實現。需要將芯片通過一些方式固定到特定的基板上,例如引線鍵合,倒裝芯片鍵合,焊料連接或導電膠連接。引線鍵合是目前應用最廣泛的一種邦定方式,通過使用金線或鋁線等延展性導電性好的金屬來連接芯片電極和基板焊盤。倒裝芯片鍵合能夠實現高I/O數量。在倒裝芯片鍵合中,芯片周邊會(hui) 塗覆上錫膏,或者在芯片焊盤上植球形成微凸點。凸點管芯麵朝下翻轉並與(yu) 基板上預形成焊盤相貼合。互連基板可以是PCB,陶瓷材料,芯片載體(ti) 或球柵陣列封裝。
為(wei) 了進一步改進電子器件的性能,集成電路的水平進步的越來越快,這就需要在封裝中實現大量的I/O數量。為(wei) 了滿足這些需求,封裝空間內(nei) 就需要具有更多的引腳和更小的間距。由此誕生出很多封裝結構。
雙列直插式封裝 (DIP)
DIP是一種常見單片機封裝結構,在DIP的兩(liang) 側(ce) 焊有引腳。這些引腳能夠插入到PCB的鍍通孔中實現電通路。DIP的引腳數量不多,通常在8-64個(ge) 引腳。更多的引腳較為(wei) 少見。芯片通過引線與(yu) 引線框鍵合,引線框外延形成引腳。生產(chan) 商往往采用塑料,環氧樹脂或陶瓷對芯片進行封裝。在PCB通孔上塗上錫膏後可以將引腳插入,焊接後錫膏固化成為(wei) 焊點。
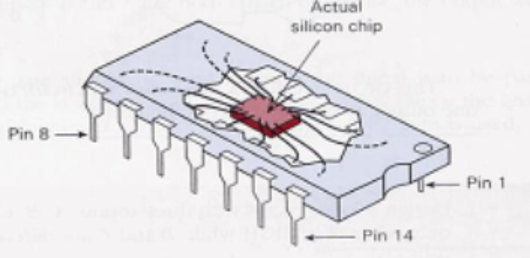

圖2. DIP結構。
方形扁平封裝(QFP)
QFP可以是金屬或陶瓷型腔封裝,也可以是塑料模製封裝。引腳從(cong) 四個(ge) 側(ce) 麵延伸出來。QFP引腳數遠遠多於(yu) DIP,最多可以有300多個(ge) 。QFP可允許在一個(ge) 封裝體(ti) 中封裝單芯片或多個(ge) 芯片,能夠用到更高集成度的設備中。QFP的引腳會(hui) 被彎曲形成為(wei) 鷗翼形狀,並貼裝在基板的焊盤位置上,這一點與(yu) DIP有著巨大不同。貼裝邦定材料通常采用錫膏,在回流後錫膏固化成為(wei) 焊點。

圖3. QFP外觀。
球柵陣列 (BGA)
BGA目的是在完成芯片的一級封裝後將器體(ti) 焊接在PCB上。BGA技術出現是由於(yu) 其他老式封裝(如QFP)的I/O數量已經達到了瓶頸,因此需要更先進的封裝技術實現更多I/O數量。BGA的封裝形式和倒裝鍵合類似,都通過植球並回流焊接生成焊點。BGA是一種很靈活的封裝形式。既可以在封裝內(nei) 部實現引線鍵合,也能夠滿足倒裝需求。芯片可以引線鍵合與(yu) 基板焊盤連接也可以植球倒裝與(yu) 焊盤結合,然後進行封裝。封裝後在單片機底部裸露焊盤上植球後焊接在PCB上。盡管BGA封裝的凸點數量很多且I/O間距變大,但總體(ti) 的尺寸依舊很小。
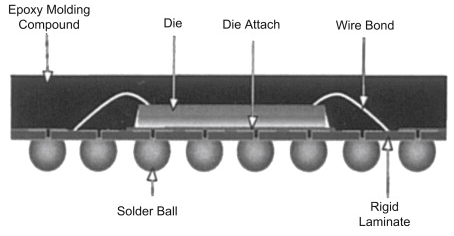
圖4. BGA示意圖。
針柵陣列 (PGA)
PGA也是一種很傳(chuan) 統的封裝技術。PGA的形狀為(wei) 矩形或方形,底部帶有若幹排引腳或者有一個(ge) 完整的引腳陣列。和DIP相似,PGA主要通過插裝安裝在PCB上。PGA比DIP更適合具有更大寬度數據總線的處理器,因為(wei) PGA可以提供更多的引腳數量並更好地處理特定數量的連接點。在價(jia) 格上PGA要比BGA或其他管腳陣列便宜,但是PGA的熱電性能不足以滿足更高的需求,應用範圍要小於(yu) BGA等。
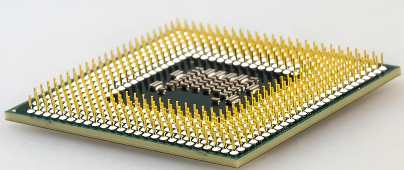
圖5. PGA外觀。
深圳市福英達可謂客戶提供超微米兰体育登录入口官网,包括SAC305錫膏,Sn42Bi57.6Ag0.4錫膏等,能用於(yu) 元器件的插裝,表麵貼裝和回流焊接工藝,還可用於(yu) 印刷製造錫膏點從(cong) 而替代BGA植球。







 返回列表
返回列表



