金錫錫膏焊點微觀結構演化-福英達錫膏


金錫錫膏焊點微觀結構演化-福英達錫膏
提到無鉛錫膏大家最熟悉的肯定是中溫錫銀銅錫膏和低溫錫鉍銀錫膏。這兩(liang) 種類型的無鉛錫膏應用範圍很廣,且其熔點從(cong) 139℃-217℃不等,能夠滿足大部分常規的封裝需求。有些領域必須要采用高溫焊料。但含鉛焊料的使用已不被允許。作為(wei) 高溫含鉛錫膏的替代品,共晶金錫錫膏(Au80Sn20)的發展已經有一段時間了,該合金具有優(you) 異的抗疲勞性能,高溫性能,耐腐蝕性和抗蠕變性。
金錫錫膏是一種很特殊的焊料,具有比傳(chuan) 統錫膏更優(you) 秀的抗氧化性和潤濕性,能夠不借助助焊劑在280℃以上完成焊接工作。比如在功率型LED芯片中往往能夠見到金錫錫膏的身影。金錫錫膏通常被電鍍在矽片上形成Au和Sn薄膜,焊接加熱後通過界麵反應形成焊點。金錫錫膏與(yu) 焊盤的界麵反應和金屬間化合物(IMC)情況影響焊接效果,需要我們(men) 了解。
金錫錫膏IMC演變
擴散機製是IMC生成的本質原因。金屬原子在焊接時通過擴散作用形成金屬間化合物。Au和Sn的相互擴散率很高,在不同溫度會(hui) 產(chan) 生金屬間化合物。通過相圖可以知道固態共晶金錫錫膏的IMC主要包括Au5Sn和AuSn。
Tsai等人在Cu基板和Ni基板上蒸鍍沉積Au80Sn20錫膏形成Sn/Au/Cu和Sn/Au/Ni夾層結構並研究了焊盤界麵處微觀結構演變。當在290℃焊接2分鍾時,發現在Ni基板界麵都會(hui) 生成(Au, Ni)5Sn和(Au, Ni)Sn。對Ni基板而言,界麵的金屬化合物層雖然都為(wei) (Au, Ni)5Sn和(Au, Ni)Sn,但是分布位置卻對調了(圖1)。
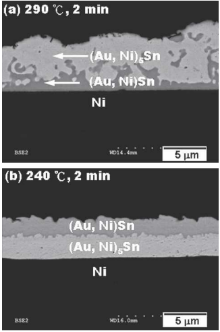
圖1. Sn/Au/Ni焊接微觀結構 (a)(Au, Ni)Sn靠近Ni一側(ce) ; (b) (Au, Ni)5Sn靠近Ni一側(ce) 。
焊接後的Cu基板處金屬化合物是以(Au, Cu)5Sn和(Au, Cu)Sn為(wei) 主(圖2)。可以知道有少量的Cu融入了Au的子晶格中。並且可以發現在不同溫度下,(Au, Cu)5Sn層中的Au和Cu的比重並不一樣。低焊接溫度使得Cu含量更低。
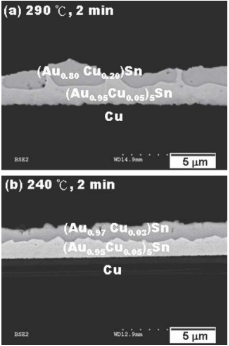
圖2. Sn/Au/Cu焊接微觀結構。
老化後焊點微觀結構
錫膏-Cu界麵
金錫錫膏焊點的微觀結構演變機製相當複雜且規律難尋,這和錫銀銅和錫鉍銀焊點微觀結構區別很大。比如Sn/Au/Cu焊點在240℃焊接並在該溫度下老化1小時後,(Au, Cu)5Sn和(Au, Cu)Sn都發生了變化。(Au, Cu)5Sn從(cong) (Au0.95, Cu0.05)5Sn變成了(Au0.7, Cu0.3)5Sn和(Au0.6, Cu0.4)5Sn。(Au0.97, Cu0.03)Sn變成了不連續的(Au0.94, Cu0.06)5Sn,這情況表明Cu在焊料中的融解顯著的增加。
在240℃老化10小時後,(Au0.94, Cu0.06)Sn沒有變化。但是出現了Cu3Au和無法確定成分的Au-Cu-Sn。雖然成分有小變化,總體(ti) 來看,(Au, Cu)5Sn總是更傾(qing) 向挨著Cu層生長。
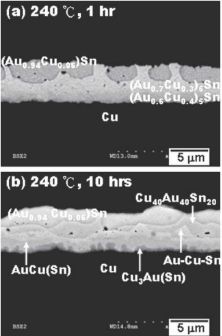
圖3. 240℃焊接和老化後Cu界麵微觀結構。
錫膏-Ni界麵
可以發現在老化1000小時後Ni界麵仍然保持較為(wei) 完整的結構。(Au, Ni)5Sn層依舊保持連續性。(Au, Ni)Sn層消失,取而代之出現了(Ni0.6, Au0.4)3Sn2和少量的不確定成分的Ni-Au-Sn。緊挨著Ni層出現(Ni0.6, Au0.4)3Sn2表明有一定量的Au融解。
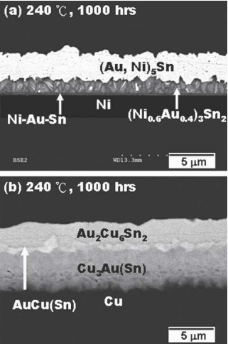
圖4. 240℃焊接和老化後Ni界麵和Cu界麵微觀結構對比。
客戶如果有高溫無鉛米兰体育登录入口官网的需求,可以與(yu) 深圳市福英達聯係。深圳市福英達有著先進的金錫錫膏生產(chan) 技術,產(chan) 品能夠滿足高溫焊接的需求。
參考文獻
Tsai, J.Y., Chang, C.W., Ho, C.E., Lin, Y.L. & Kao, C.R. (2006). “Microstructure Evolution of Gold-Tin Eutectic Solder on Cu and Ni Substrates”, Journal of Electronic Materials, vol.35(1).







 返回列表
返回列表



