BGA錫膏和BGA植球工藝類型-深圳市福英達


BGA錫膏和BGA植球工藝類型-深圳市福英達
隨著大規模集成電路的快速發展,傳(chuan) 統封裝技術如通孔插裝無法滿足高密度封裝的需求。而出於(yu) 高集成度,小封裝尺寸和更多I/O數量的需求,新的封裝工藝應運而生。球柵陣列(BGA)封裝突破了傳(chuan) 統封裝的限製,目前是應用領域廣泛的一種新封裝技術。BGA植球常見的類型有激光植球,印刷植球,手工植球和移印植球。
激光植球法
激光植球多用於(yu) 小批量植球生產(chan) 中,操作簡單且工藝流程短。激光植球的機理是將錫球放入激光植球機中。植球機內(nei) 部激光加熱將錫球單獨回流熔化成液態,然後液態錫通過噴嘴滴落到BGA焊盤上完成植球。激光植球需要通氮氣保護,避免回流時發生氧化現象。
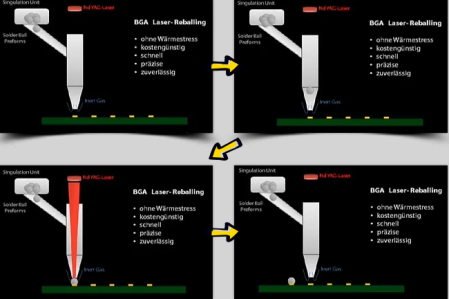
圖1. 激光植球工藝。
印刷植球方案
印刷植球和SMT錫膏印刷過程相似,都需要用到鋼網。印刷植球工藝需要將小鋼網對位並定位到BGA焊盤上,然後進行錫膏印刷作業(ye) ,而不是使用預成型焊料球。經過回流後錫膏固化收縮成為(wei) 錫球。印刷植球的缺陷是錫球均勻性有限,共麵性不足。T6及以上的錫膏具有小粒徑的特點,能夠取代預成型錫球用於(yu) 小尺寸BGA植球。
錫膏印刷工藝是無鉛錫膏從(cong) 鋼網轉移到焊盤的過程,涉及鋼網,錫膏和自動印刷機。錫膏印刷工藝對印刷植球可靠性影響很大。在確認了BGA植球所需錫膏量後,需要定製合適開孔布局的鋼網。測定BGA植球所需錫膏量通常需要考慮以下因素。
1. 錫膏量充足以確保良好的BGA尺寸。
2. 選擇焊膏量應考慮BGA元件的焊球共麵誤差(通常為(wei) 0.1mm)。
3. 當電路板上有其他細間距組件時,應綜合考慮錫膏量,以防止出現更多的焊接缺陷。
手工植球法
手工植球不適合大規模生產(chan) ,一般用在BGA返修植球或打樣植球。手工植球需要用到小鋼網。鋼網對位到焊盤位置並將錫球放置在網孔中。在移開鋼網後進行回流加熱將錫球熔化完成植球。
移印植球工藝
移印植球是實現BGA大批量,高效率植球的成熟工藝,在數秒內(nei) 就能完成上萬(wan) 顆錫球植球。移印植球的流程大致可分為(wei) 以下幾個(ge) 步驟。
1. 將BGA焊盤朝上放置在傳(chuan) 送軌道上。根據廠家的生產(chan) 能力,一次植球的數量為(wei) 4-20顆BGA。
2. 根據BGA要求選擇特定的針管。如果每顆BGA有1000個(ge) 錫球,則每區塊針管陣列由1000個(ge) 針管組成。如果植球4顆BGA,則需要用到4個(ge) 針管陣列(4000個(ge) 針管)。針管的作用是沾取助焊膏並轉移移印到4顆BGA對應的焊盤上。移印完成後將BGA傳(chuan) 送到下個(ge) 環節。
3. 將BGA錫球堆疊在針管上並通真空。每個(ge) 針管吸取一顆錫球並對準移印了助焊膏的BGA焊盤,然後關(guan) 閉真空並吹氣將錫球放置在焊盤上。完成錫球放置後將焊盤進行回流加熱,錫球熔化完成植球。
深圳市福英達的適用於(yu) BGA植球工藝。福英達超微米兰体育登录入口官网在回流焊接後形成的錫球尺寸合適,光滑度高,機械強度優(you) 秀,能夠很大程度取代預成型焊料球。







 返回列表
返回列表



