BGA錫膏焊點高度對固液擴散的影響-深圳福英達


BGA錫膏焊點高度對固液擴散的影響-深圳福英達
在SMT和BGA作業(ye) 中大多數情況都要用到錫膏作為(wei) 連接芯片和基板。再完成回流焊接後,錫膏會(hui) 固化成為(wei) 堅固的導電性優(you) 秀的焊點。焊點的性質決(jue) 定了焊接強度等性能是否能夠滿足需求。固液界麵擴散是在回流時發生的一種機製。銅焊盤原子會(hui) 溶解進入焊料中並形成特定金屬間化合物(IMC)。焊點界麵IMC的演變在老化過程中具有幾何尺寸效應。界麵擴散的尺寸效應主要集中在焊點體(ti) 積和焊盤金屬化層厚度對界麵擴散的影響。為(wei) 了深入了解焊點高度對固液擴散的影響。Li等人測試了不同高度的SAC305焊點與(yu) 對固液界麵擴散的影響。
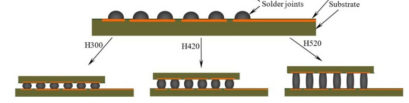
圖1. 用於(yu) 測試的焊點。H300: 高度300μm;H420: 高度420μm;H520: 高度520μm
實驗結果
在230℃下老化0.5小時後,H300,H400和H520焊點的IMC厚度分別為(wei) 6.419μm,7.358μm和8.294μm,對應的銅焊盤消耗量分別為(wei) 3.691μm,4.069μm和4.553μm。可以看到焊點高度越高,IMC厚度越大,銅原子消耗越多。
在張力作用下原子擴散的速度會(hui) 更快。由於(yu) H300在回流時處於(yu) 受壓狀態,而H400和H520受到張力作用,且焊點高度越高則張力作用越明顯。 因此H520焊點中Cu原子從(cong) 焊盤擴散到焊料的速度最快,界麵IMC厚度最大。

圖2. 不同高度焊點的IMC厚度。
在230℃熱老化0.5h時,Cu6Sn5仍保持為(wei) 固態(Cu6Sn5的熔點為(wei) 415℃)。 因此,Cu 和 Sn 原子將在較高的焊點的 IMC 層上經曆更長距離的固體(ti) 擴散。 由於(yu) 擴散距離變長,經過相同的擴散時間後,在高度更高的SAC305焊點中完成擴散的 Cu 和 Sn 原子更少。此外,由於(yu) 焊點高度增加而導致焊料的Cu原子更多,使得高焊點的焊盤與(yu) 焊料之間的濃度梯度較小,原子擴散驅動力降低。因此界麵IMC層生長速率和Cu焊盤消耗速率隨著焊點高度的增加而降低。
深圳市福英達有這豐(feng) 富的錫膏焊料生產(chan) 經驗,能為(wei) 客戶提供合適熔點和性能的超微米兰体育登录入口官网。福英達可以隨時為(wei) 客戶解決(jue) 有關(guan) 焊料的疑難點。歡迎與(yu) 我們(men) 聯係。
參考文獻
Li, X.M., Wang, L.P., Li, X.W., Li, C., Sun, F.L., Meng, L., Zhu, L. & Li, M. (2022). The effects of solder joint height on the solid–liquid interface diffusion in micro solder joints. Materials Letters. vol. 316.







 返回列表
返回列表



