電鍍雜質引起的焊點空洞值得我們了解-深圳市福英達


電鍍雜質引起的焊點空洞值得我們(men) 了解-深圳市福英達
空洞是伴隨著錫膏或焊料球回流焊接時產(chan) 生的現象。空洞被普遍認為(wei) 是導致焊點導熱性和機械強度弱化的一個(ge) 原因。在對空洞生成進行成因分析時,我們(men) 很容易聯想到助焊劑。助焊劑的溶劑蒸發和有機酸反應都會(hui) 形成氣泡,不能及時逃逸的氣泡就會(hui) 形成空洞。還有一種空洞叫柯肯達爾空洞,這是由於(yu) 焊料成分擴散速度不同導致的。基板雜質對空洞形成的影響往往被人們(men) 忽略。
雜質效應實驗
電鍍銅是一種普遍使用的製備基板的工藝。當使用電鍍工藝製備銅基板時可能會(hui) 有雜質 (碳、硫、氯等)混入電鍍銅基板中。為(wei) 了了解雜質對焊點空洞形成的影響,Hsu等人將Sn焊料球在260℃溫度下焊接在電鍍銅基板上。電鍍銅基板的製備用到銅箔和電鍍添加劑配方PEG+Cl-。 焊接完成後,Hsu等人將Sn/Cu焊點樣品放在120、150和200℃的爐子中 進行144小時老化測試,隨後觀察焊點微觀結構。
實驗結果
Sn球和Cu基板在焊接時會(hui) 在界麵處形成Cu6Sn5,並在老化時逐漸生長。電鍍雜質往往會(hui) 在焊點老化過程蒸發進入到焊料/基板界麵,從(cong) 而占據Cu6Sn5的位置並變成空洞。如圖1所示,在晶粒的表麵出現了不同大小的空洞。當焊點在老化時,晶界處的空洞會(hui) 阻礙晶界的遷移,減小晶粒的積聚。類似於(yu) 柯肯達爾空洞,雜質引起的空洞也會(hui) 使得焊點出現脆化現象。

圖1. 電鍍PC-Cu的SEM圖。
為(wei) 了判斷助焊劑是否會(hui) 對電鍍PC-Cu的空洞產(chan) 生影響,Hsu等人還采用了無助焊劑工藝進行焊接。結果發現Cu6Sn5表麵仍然存在空洞。因此可以認為(wei) 助焊劑並不是電鍍PC-Cu空洞形成主要原因。
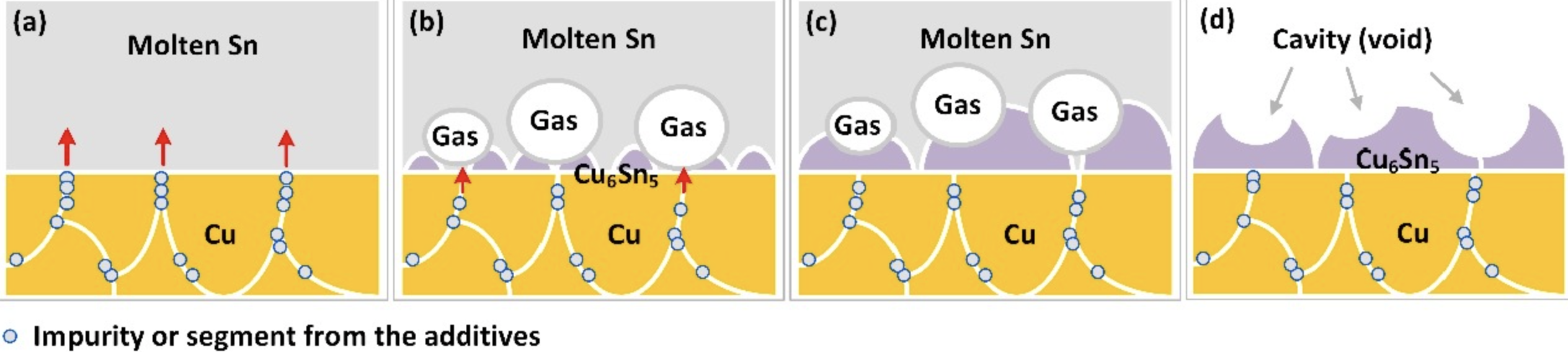
圖2. 電鍍添加劑雜質進入焊料的示意圖。
低空洞錫膏
深圳市福英達能夠生產(chan) 優(you) 質的超微錫膏(T6及以上)。福英達經過大量經驗積累設計了可靠的助焊劑配方。在製備錫膏後潤濕性良好,空洞率小,焊點強度高,能夠用於(yu) 微小間距焊接。歡迎與(yu) 我們(men) 聯係合作。
參考文獻
Hsu, H.L., Lee, H., Wang, C.W., Liang, C.J. & Chen, C.M. (2019). Impurity evaporation and void formation in Sn/Cu solder joints. Materials Chemistry and Physics, vol.225, pp.153-158.







 返回列表
返回列表



