熱梯度在錫膏焊接中的應用-深圳市福英達


熱梯度在錫膏焊接中的應用-深圳市福英達
當前微電子行業(ye) 的封裝朝著高密度和小體(ti) 積方向發展,此舉(ju) 顯然是為(wei) 了拓展摩爾定律。因此在封裝中用到的錫膏/焊點往往直徑細小。微小焊點內(nei) 的晶粒的類型和性質對於(yu) 研究焊點的性質變得至關(guan) 重要。熱梯度鍵合是一種目前討論較多的焊接方法,不少人認為(wei) 熱梯度的應用能夠通過固液互擴散鍵合控製金屬間化合物(IMCs)定向生長,從(cong) 而獲得特定性能的微小焊點。與(yu) 之相反的是,固液互擴散鍵合在等溫條件下需要很長時間來形成完整的IMCs,並且IMCs的取向很難精確控製。
1. 熱梯度鍵合實驗
為(wei) 了深入了解熱梯度對焊接的影響。Zhang等人采用了SAC305來鍵合上下端的銅焊盤。兩(liang) 個(ge) 銅焊盤的尺寸都為(wei) 10×10×2mm。熱梯度鍵合采用加熱台來實現,加熱台的熱端溫度為(wei) 400℃,冷端溫度為(wei) 100℃。
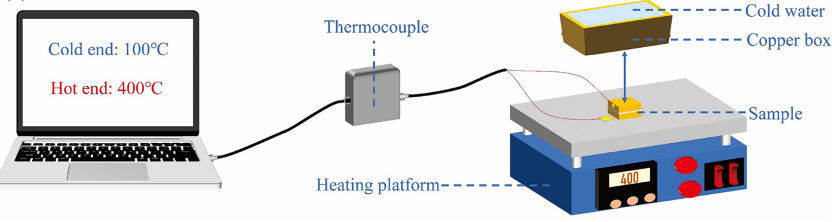
圖1. 熱梯度鍵合實驗。
2. 熱梯度鍵合實驗結果
在加熱過程中,可以明顯觀察到Cu6Sn5的形成。在Cu6Sn5和Cu焊盤之間的較薄IMC層是Cu3Sn。從(cong) 圖中可以發現,熱梯度鍵合使IMCs生長速度發生變化。在熱端IMCs沒有表現出明顯的生長,而冷端的IMCs生長速度很快。隨著鍵合時間的增加,冷端IMCs數量顯著增加,而熱端IMCs變化不明顯。此外,隨著焊料層厚度增加,Cu6Sn5在熱梯度鍵合焊點中呈現出細長的柱狀形態。不同的是,等溫焊接下的IMCs在焊點兩(liang) 端基本是對稱生長。

圖2. 熱梯度鍵合的IMC生長。焊料層厚度: (a)20μm; (b)60μm; (c)100μm。
當焊料層厚度為(wei) 20μm時,熱梯度鍵合冷端IMCs的生長速度最快。隨著厚度增加,冷端IMCs生長速度受鍵合時間的影響會(hui) 逐漸減弱。因此熱梯度鍵合可以通過控製焊料層厚度和鍵合時間來製造全IMC焊點。
下圖顯示了Cu/SAC305/Cu焊點中Sn晶界的錯位取向分布。等溫鍵合和熱梯度鍵合的錯位取向分布大致在0°-15°和55°-65°之間。然而,等溫鍵合會(hui) 使Sn晶界的錯位取向分布更為(wei) 分散,而熱梯度鍵合能讓對單個(ge) 焊點中的Sn分布更集中。

圖3. Sn晶界的錯位取向分布。焊料層厚度:(a)20μm(熱梯度); (b)60μm(熱梯度); (c)100μm(熱梯度); (d)100μm(等溫)。
3. 福英達錫膏
深圳市福英達在焊料界深耕多年,有著豐(feng) 富的SAC305,SnBi57.6Ag0.4等錫膏焊料的開發經驗,產(chan) 品焊接強度優(you) 秀,粘度可定製化,可適用於(yu) 印刷和點膠等多種工藝。歡迎客戶與(yu) 我們(men) 了解更多產(chan) 品信息。
4. 參考文獻
Zhang, Z.Z., Hu, X.W., Chen, W.J., Tan, S.F., Chen, B., Wang, J., Jiang, J., Huang, Y.F., Zhu, G.Y., He, Y.S., Jiang, X.X. & Li, Q.L. (2023). Study of microstructure, growth orientations and shear performance of Cu/Sn-3.0Ag-0.5Cu/Cu solder joints by using thermal gradient bonding. Materials Characterization, vol.203.







 返回列表
返回列表



