ENIG化學鎳金板中IMC的異常生長與開裂-深圳市福英達


ENIG化學鎳金板中IMC的異常生長與開裂
ENIG(Electroless Nickel Immersion Gold)是一種廣泛應用於(yu) PCB表麵處理的工藝,也被稱為(wei) 沉金板或化學鎳金板。相比於(yu) 電鍍金板,ENIG的金層更薄且密度較低。一般要求鎳層厚度為(wei) 3-5μm,金層厚度為(wei) 0.05-0.15μm(通常控製在0.07-0.1μm範圍內(nei) )。當需要在ENIG表麵進行焊接工藝時,需要增加鎳層厚度至4-7μm。ENIG處理後的焊盤表麵平整,在密間距器件的印刷貼裝製程中具有良好的使用效果。金層具備良好的導電性和耐磨性,可直接作為(wei) 接觸導通麵使用。此外,金層還具有抗氧化 和抗腐蝕能力,能有效保護底層的鎳層不被氧化,從(cong) 而保持良好的焊接能力。
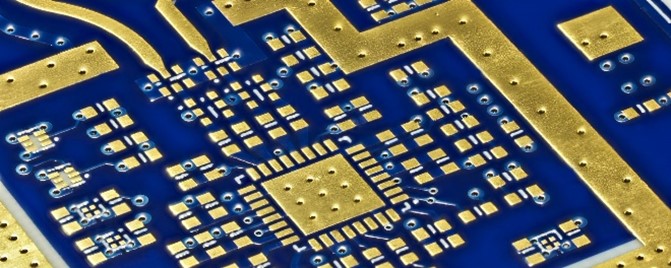
圖1. ENIG鎳金焊盤
然而,使用ENIG化學鎳金板進行焊接時,可能會(hui) 出現焊盤上金屬間化合物(IMC)的異常生長與(yu) 開裂問題。本文將探討該問題的成因以及可能的解決(jue) 方法。
IMC生長與(yu) 熱脆性
錫銅間金屬化合物在高溫長時間作用下會(hui) 出現熱脆性現象。這是由於(yu) 液態焊錫與(yu) 銅形成的IMC呈鵝卵石狀(切片呈扇貝狀),晶界間存在縫隙,使得液態焊錫與(yu) 焊盤銅箔持續不斷地生成Cu6Sn5,並使較小的晶粒並入較大的晶粒內(nei) 。當晶粒生長到一定尺寸時,底部基材已無法承受,晶粒會(hui) 自行斷裂跌落進入焊點內(nei) ,這種現象稱為(wei) 跌落。因此,控製IMC層的厚度非常重要,過厚的IMC層會(hui) 導致熱脆性和開裂問題的發生。
IMC分層與(yu) 跌落
錫鎳間IMC分層與(yu) 跌落問題源於(yu) IMC的多次生長。在第一次回流焊接過程中形成的錫鎳IMC層會(hui) 在第二次回流焊接製程中被底部新生成的IMC層推浮上升。如果第一次IMC層過厚,第二次IMC層同樣很厚,那麽(me) 後生成的IMC將排擠原有的IMC層,導致固有IMC層的分離並脫落進入焊點內(nei) 。因此,在焊接過程中,無論是錫銅間金屬化合物還是錫鎳金屬化合物,都需要控製其厚度。IMC層的厚度應盡量薄,但必須存在,否則將無法形成可靠的焊點。
影響IMC生長的因素
(a)焊接時間過長和溫度過高:過長的焊接時間和過高的焊接溫度會(hui) 加速IMC的生長速度,導致IMC層厚度超過正常範圍。
(b)化學鎳層粗糙度過大:粗糙的化學鎳層會(hui) 加速IMC的溶解,從(cong) 而促進IMC的生長。
(c)存在鎳層上浮現象:如果鎳層上浮,遊離的鎳將直接溶解進入焊錫中,進一步增加IMC的厚度。
通過嚴(yan) 格控製焊接時間和溫度、控製化學鎳層粗糙度以及避免鎳層上浮現象,可以減少IMC的厚度,提高焊點的可靠性和機械強度。進一步的研究和優(you) 化ENIG工藝參數對於(yu) 解決(jue) IMC異常生長與(yu) 開裂問題具有重要意義(yi) ,以滿足高可靠性電子製造的需求。







 返回列表
返回列表



