BGA、CSP封裝中的球窩缺陷-福英達錫膏


BGA、CSP封裝中的球窩缺陷
隨著BGA、CSP封裝器件向密間距、微型化的方向發展,無鉛製程的廣泛應用給電子裝聯工藝帶來了新的挑戰。球窩(Pillow-head Effect)缺陷是BGA、CSP類器件回流焊接中特有的一種缺陷形態。如圖所示,焊料球和焊錫之間沒有完全熔合,而是像枕頭一樣放在一個(ge) 窩裏或一個(ge) 堆上。這種缺陷經常發生在BGA、CSP器件的回流焊接中,在無鉛製程中更為(wei) 突出。
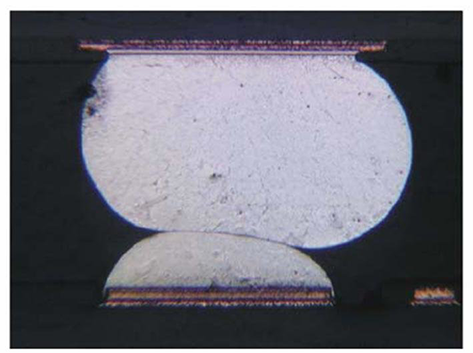
圖1.球窩現象
球窩缺陷不易被檢測出來,因為(wei) 焊料球和焊錫之間往往有部分連接。所以電路可能能夠通過功能測試、光學檢查和ICT測試。但是,由於(yu) 焊料之間沒有真正熔混,焊點不牢固,可能會(hui) 在後續的工藝或使用過程中導致失效。例如,在焊接工藝之後,存在球窩缺陷的PCBA可能會(hui) 在後續的組裝工藝、運輸過程中因為(wei) 熱脹冷縮或者在現場經受長時間的電流負荷而失效。因此,球窩缺陷的危害性是極大的。
1.錫膏或焊料球的可焊性不良。
2.錫膏印刷和貼片精度影響。如果錫膏印刷不均勻或不準確,或者貼片位置偏移,會(hui) 導致焊料球和焊錫之間的接觸不良,從(cong) 而形成球窩。
3.BGA焊球的共麵性不好。如果BGA封裝器件的焊球高度不一致,會(hui) 導致部分焊點受力不均勻,從(cong) 而造成翹曲或斷裂。
4.芯片翹曲或芯片溫度不均勻,存在溫差。如果芯片在回流焊接過程中受熱不均勻,或者在回流焊接前後發生翹曲,都會(hui) 導致芯片與(yu) PCB基材之間的熱膨脹係數不匹配,從(cong) 而產(chan) 生應力和變形。這會(hui) 使得部分焊點失去接觸或分離,形成球窩。
1.優(you) 化回流溫度曲線,保證錫膏能夠完全液化並與(yu) 焊料球充分熔合。
2.選用合適的錫膏:采用抗熱坍塌能力強,去CuO(Cu2O)、SnO(SnO2)效果良好的錫膏。
3.改善熱風回流的均熱能力,最好采用“熱風+紅外”複合加熱方式,能有效改善封裝體(ti) 上溫度的均勻性。
4.加強對回流爐排氣係統的監控,確保排氣管道順暢有效。
深圳市米兰app官方正版官网入口自主研發和生產(chan) 的SiP係統級封裝錫膏Fitech siperiorTM 1550/1565,粒徑T8、T9,最小印刷/點膠點φ=70/50μm,可穩定用於(yu) μBGA預置。在實際應用中體(ti) 現出優(you) 異的印刷性、脫模轉印性、形狀和穩定保持性及足量且均勻的印刷量。長時間印刷後無錫珠、橋連缺陷。歡迎來電谘詢。







 返回列表
返回列表



