倒裝芯片封裝選擇什麽樣的錫膏?

近幾年,倒裝芯片(Flip-chip)技術越來越多地在消費類電子、高性能產(chan) 品上應用。在倒裝芯片封裝過程中,無鉛錫膏可被用於(yu) 基板凸點製作、模塊及板級連接等。在實際應用中應該選擇什麽(me) 樣的無鉛錫膏呢?
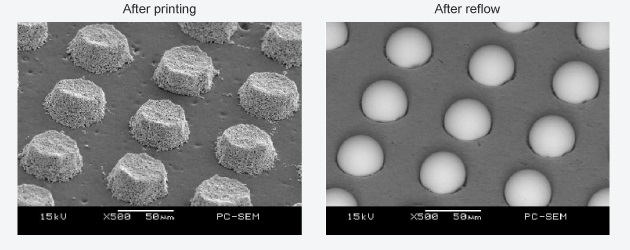
結合自身情況考慮工藝特性
由於(yu) 無鉛錫膏性質特點,無鉛錫膏許多特性間存在需要取舍的矛盾關(guan) 係,這就造成了不可能有完美的產(chan) 品,而需要根據工藝特性選擇錫膏。例如,當選定合金焊料後,若要增大錫膏在被焊金屬表麵的潤濕性,就需要增大錫膏助焊劑的活性,而活性的增大就會(hui) 增大焊接後被焊表麵被助焊劑殘留物腐蝕的可能。

還要考慮倒裝芯片多次階梯回流的要求。芯片倒裝焊接後,還需要進行模塊或板級互聯,維持焊料熔點層級要求必須在選擇錫膏是考慮。
考慮焊接後倒裝芯片互聯結構的可靠性
熱疲勞可靠性、跌落衝(chong) 擊可靠性以及電遷移可靠性等是影響倒裝芯片互聯結構可靠性的重要影響因素。
有研究表明,對於(yu) 不同周期的熱循環,不同合金成分錫膏焊點所顯示的焊點疲勞壽命不同。在0~100℃、120min的長周期熱循環條件下,低Ag含量[2.1%(質量分數)]無鉛錫膏焊點的熱疲勞壽命最長,而在0~100℃、30min的短周期熱循環條件下,高Ag含量[3.8%(質量分數)]無鉛錫膏焊點的疲勞壽命最長。可見,在選用錫膏時還需要根據工藝條件選擇合適的錫膏提高可靠性。
倒裝芯片封裝應該選擇什麽(me) 樣的無鉛錫膏是一個(ge) 需要多方麵綜合考慮的問題,既要包括工藝條件又要包括錫膏特性。選擇一個(ge) 適合的倒裝芯片無鉛錫膏最簡單的方式就是通過下方的聯係方式聯係我們(men) ,我們(men) 的工程師將和您一起選擇適合的無鉛焊料產(chan) 品。







 返回列表
返回列表



