QFN封裝橋連現象分析與改進建議-深圳福英達


QFN封裝橋連現象分析與改進建議
QFN封裝中的橋連現象,尤其在雙排QFN的內(nei) 排焊點間較為(wei) 常見,而單排QFN則相對較少出現。橋連是由於(yu) 焊料被擠壓到非潤濕麵而形成的,這通常會(hui) 導致電氣短路,嚴(yan) 重影響電路的性能和可靠性。如圖下圖所示。
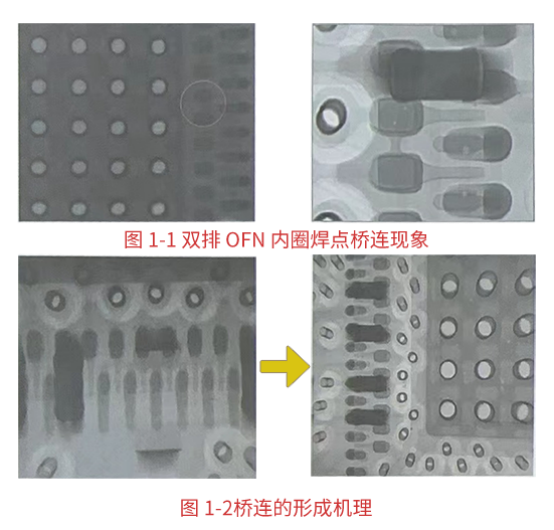
二、產(chan) 生原因
焊料擠壓:QFN封裝底部有一個(ge) 大麵積的熱沉焊盤,它決(jue) 定了焊縫的高度。熱沉焊盤上的焊膏通常不是印刷成一個(ge) 整體(ti) 圖形,而是采用窗格式或條紋式,以排氣並控製焊縫中的空洞。然而,這種設計減小了焊膏的覆蓋麵積,減少了焊膏的總量。在QFN再流塌落時,引腳焊料會(hui) 向外擠壓,容易引發橋連。
QFN變形:QFN封裝的變形也是導致橋連的原因之一。當QFN內(nei) 外排焊點的高度相差較大時(有時相差十多微米),焊料在再流過程中更容易受到擠壓和流動,從(cong) 而增加橋連的風險。
空洞率與(yu) 橋連的對應關(guan) 係:通常,橋連與(yu) 信號焊盤的空洞率有對應關(guan) 係。橋連率高時,往往空洞也會(hui) 更多。這進一步證明了焊料擠壓和排氣不良是導致橋連的主要原因。
三、改進建議
針對QFN封裝橋連現象的產(chan) 生原因,我們(men) 可以從(cong) 以下幾個(ge) 方麵進行改進:
減少內(nei) 圈焊膏印刷量:理論上,應根據熱沉焊盤的焊盤覆蓋率設計同等量的漏印麵積。考慮到QFN本身焊盤比較小、印刷難度大,通常可以通過縮減內(nei) 圈焊盤開口的尺寸來減少焊膏量。這樣可以降低焊料在再流過程中的擠壓程度,減少橋連的風險。雙排 QFN 防橋連設計建議如下圖所示
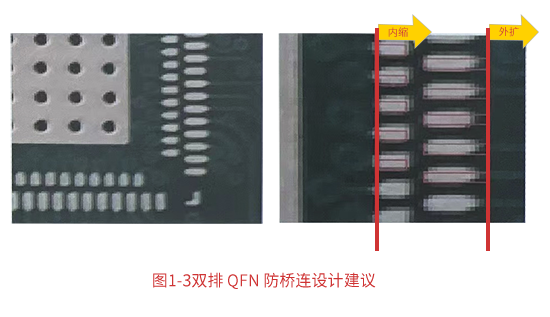
提供容錫空間:通過焊盤間去阻焊設計、寬焊盤窄開口工藝設計以及熱沉焊盤阻焊定義(yi) 等方法,為(wei) 焊料提供更多的容錫空間。這有助於(yu) 減少焊料在再流過程中的擠壓和流動,從(cong) 而降低橋連的風險。然而,需要注意的是,對於(yu) 小焊盤而言,過度增加容錫空間可能會(hui) 導致應力集中問題,因此需要謹慎設計。
綜上所述,QFN封裝橋連現象的產(chan) 生原因主要包括焊料擠壓、QFN變形以及空洞率與(yu) 橋連的對應關(guan) 係。針對這些問題,我們(men) 可以從(cong) 減少內(nei) 圈焊膏印刷量和提供容錫空間兩(liang) 個(ge) 方麵進行改進。通過合理的工藝設計和優(you) 化,我們(men) 可以有效降低QFN封裝橋連的風險,提高電路的性能和可靠性。
-未完待續-
*免責聲明:本文由作者原創。文章內(nei) 容係作者個(ge) 人觀點,轉載僅(jin) 為(wei) 了傳(chuan) 達一種不同的觀點,不代表對該觀點讚同或支持,如有侵權,歡迎聯係我們(men) 刪除!除了“轉載”文章,本站所刊原創內(nei) 容著作權屬於(yu) 深圳福英達,未經本站同意授權,不得重製、轉載、引用、變更或出版。







 返回列表
返回列表



