Mini LED 封裝 (SMD、IMD、COB、正裝、倒裝)

Mini LED 封裝 (SMD、IMD、COB、正裝、倒裝)
LED封裝的目的在於(yu) 保護芯片、並實現信號連接,起到穩定性能、提高發光效率及提高使用壽命的作用。主要工藝流程分為(wei) :固晶、焊接、封膠、烘烤、切割、分BIN和包裝等階段。LED封裝按照不同的封裝路線可分為(wei) SMD、IMD和COB三類;按芯片正反方向可分為(wei) 正裝、倒裝兩(liang) 類;按封裝基板材料可分為(wei) PCB基板封裝和玻璃基板封裝兩(liang) 類。
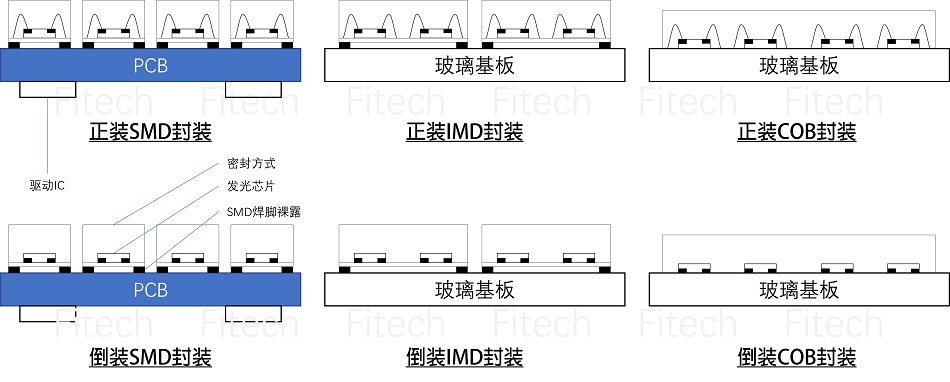
SMD
LED表麵貼裝將單個(ge) 發光芯片封裝然後分別焊接在PCB上。這樣的工藝較易實現。對於(yu) MiniLED這種含有大量芯片的技術,如果使用SMT技術則SMD數量太多,難以滿足高封裝密度,且貼片耗時長,增加檢修難度。如果選擇采用間距P1.0以上的顯示模組,那麽(me) SMD仍然會(hui) 是優(you) 秀的選擇。
IMD
矩陣集成封裝 (IMD)是將兩(liang) 組、四組乃至更多組的RGB芯片封裝在一個(ge) 小器件單元中。典型的IMD封裝以2*2或四合一的形式存在。四合一的意思是每個(ge) IMD封裝中包括4個(ge) 像素組,每個(ge) 像素組由RGB三色芯片組成。IMD常見的使用案例是間距P0.9的顯示模組。IMD的工藝流程大致分為(wei) : 固晶,焊線,壓模,烘烤,劃片,測試分選和編帶。
與(yu) 傳(chuan) 統SMD相比,IMD具有更好的防碰撞性能和更高的貼片效率。而且IMD具有高顏色一致性,易分BIN性能、SMT工藝兼容性、易返修等優(you) 點,目前也有不少使用。但是和SMD技術一樣,由於(yu) mini-LED需要高密度封裝,IMD也麵臨(lin) 著封裝密度難以突破的限製。
COB
COB技術能將多個(ge) LED芯片與(yu) 基板互連並封裝到一起。在同樣麵積下,COB LED可以比傳(chuan) 統LED實現更多光源。此外COB技術不使用支架,而是將芯片直接焊接到基板上,減少了焊點數,因此失效率會(hui) 降低。COB的技術路線以間距P0.9和P1.2的產(chan) 品為(wei) 主。COB的工藝路線包括錫膏印刷,固晶,回流焊,自動光學檢測AOI,點亮測試,返修和覆膜。采用倒裝技術的COB具有很多優(you) 勢,如散熱性好、可靠性高、保護力度更強以減少維修成本等。一般來說COB的成本會(hui) 比較高。
因為(wei) MiniLED芯片尺寸變小,其單位麵積上芯片數量暴增,因此在封裝階段固晶裝置要提高轉移效率。固晶裝置是封裝階段的重要裝置,負責將晶片獲取後貼裝到PCB或玻璃基板上並完成缺陷檢測。因MiniLED單位麵積芯片數量暴增,固晶設備轉移速度和固晶精度在一定程度上決(jue) 定了封裝良率,是降低成本、實現量產(chan) 的關(guan) 鍵。現在固晶轉移方案主要包括拾取放置方案(Pick&Place)、刺晶方案和激光轉移方案,其中Pick&Place為(wei) 目前主流應用技術,成熟度和性價(jia) 比比較高。
除此之外,測試返修環境目前仍未形成標準化的技術路徑。MiniLED要在芯片出廠前完成光電測試,並完成色度學參數測試與(yu) 返修,確保最終產(chan) 品的良率。該領域裝置種類繁多,並且因對微米級尺寸且數量龐大的燈珠完成有效測試與(yu) 修複的難度很大,目前仍未形成標準化的技術路徑。
MiniLED焊接材料
倒裝技術在MiniLED中扮演重要作用,能夠消除焊線的使用,同時也允許更小點間距的封裝。倒裝結構的LED芯片在固晶和焊接階段需要用到錫膏/錫膠材料起到物理和電氣連接功能。錫膏是采用合金焊粉和助焊膏(鬆香)結合而成。而錫膠是由合金焊粉與(yu) 助焊膠(環氧樹脂)混合調製而成。錫膠在MiniLED中有著巨大潛能,既能免清洗,也能夠為(wei) LED芯片提供更加優(you) 秀的焊點強度,這是因為(wei) 錫膠焊後會(hui) 形成環氧樹脂熱固膠並包裹住焊點,起到吸收應力的作用。
深圳市福英達生產(chan) 的T6及以上超微錫膏和超微錫膠能滿足MiniLED的低溫和中溫焊接要求,焊點推拉力優(you) 秀,機械強度高,導電性能優(you) 異。歡迎與(yu) 我們(men) 聯係了解更多MiniLED焊接信息。








 返回列表
返回列表



