MEMS封裝焊接介紹

MEMS封裝焊接介紹
1. MEMS封裝介紹
MEMS是將微傳(chuan) 感器,微執行器,信號處理,電路等元件連接在一起的係統,目前主要用於(yu) 各類傳(chuan) 感器。在對IC封裝進行長時間的研究後,人們(men) 決(jue) 定將IC封裝理論的實踐延伸到MEMS中。盡管許多MEMS封裝形式是IC封裝的延伸,MEMS的高度複雜性加大了封裝難度和成本。通常來說MEMS封裝成本占到了總設備費用的一半或更高,是因為(wei) MEMS的獨特性導致沒有標準的封裝技術。傳(chuan) 統的IC封裝需要提供芯片管腳的合理分布並且能夠實現電氣連通。不同的是由於(yu) MEMS應用場景的不同,封裝外殼需要為(wei) 各種能量和介質的流通提供通道,例如光信號,電信號,流體(ti) 成分等的流通,這加大了封裝難度。
2. MEMS封裝要求
由於(yu) 要接收外界信號和介質,MEMS不可避免要與(yu) 外界接觸。由於(yu) 體(ti) 積太小且封裝外殼需要與(yu) 外界保持連通,應用環境中的雜質會(hui) 腐蝕元件並影響可靠性。另外封裝時產(chan) 生的震動,衝(chong) 擊,溫度變化會(hui) 影響機械結構脆弱的元件可靠性和性能。為(wei) 減少對敏感高精度傳(chuan) 感器的影響,焊接受到的應力應控製在盡量小的範圍。內(nei) 部電路係統需要有效與(yu) 外部環境隔絕開來。MEMS往往是不可拆卸清洗的,因此需要焊接點揮發物保持在低量範圍。過量的揮發殘留物會(hui) 影響元件的可靠性。
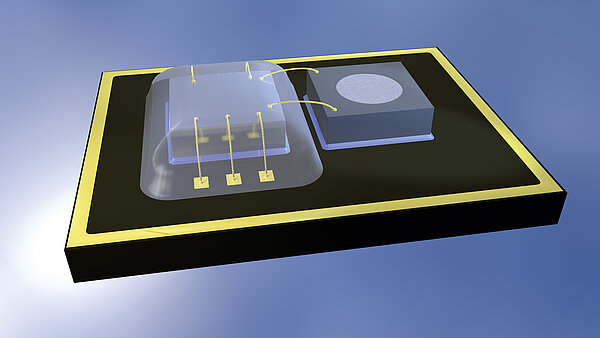
3. MEMS封裝工藝
相比於(yu) 常用的引線鍵合,目前還探索了新型的倒裝封裝技術。倒裝芯片顧名思義(yi) 就是將芯片倒裝焊接在基板上的技術,其優(you) 點是大大增加了I/O的數量。相比引線鍵合,倒裝技術避免了引線產(chan) 生的信號幹擾。單芯片/多芯片封裝和晶圓級(WLP)很好的應用了該技術。為(wei) 了使元件保持高精度,封裝焊接通常是在真空下完成。
① 單芯片/多芯片封裝
芯片級封裝是將芯片從(cong) 大塊晶圓中取出後進行封裝。主要采用陶瓷或玻璃基板進行封裝。MEMS芯片和陶瓷基板的工藝不同導致了它們(men) 需要單獨加工。MEMS芯片通過貼片,引線鍵合或直接倒裝與(yu) 基板連接,然後將芯片與(yu) 陶瓷基板相焊接並進行封帽處理。常見的封帽材料有金屬,陶瓷等。封帽的主要目的時能給芯片帶來高氣密性和可靠性。
② 晶圓級封裝。
晶圓級封裝是在還未進行切割的大塊晶圓上直接進行封裝的技術。需要對晶圓鈍化層進行聚合物塗覆,對銅焊區域線層重新排布後進行第二層聚合物塗覆,加入球下金屬層,並進行植球。進行封裝測試後將大塊完整晶圓進行切割取出單個(ge) 的成品芯片,隨後芯片在經過性能檢測後被倒裝焊在基板上,其中需要使用錫膏/錫膠進行粘連焊接。芯片最後通過多種鍵合工藝與(yu) 封帽形成互連結構。
目前兩(liang) 種封裝線路仍存在缺陷,但是晶圓級封裝隨著技術的演變無疑是MEMS封裝的主流線路,不同廠家逐漸開發出不同晶圓級封裝的分支路線。







 返回列表
返回列表



