MEMS激光焊接

MEMS激光焊接
現如今隨著集成電路發展,越來越多焊接技術被開發以滿足微小元件焊接需求。激光焊接的出現使細小元件焊接變得更高效和精準。激光焊接發展速度很快,已經逐漸被越來越多半導體(ti) 生產(chan) 商采用。
MEMS封裝時可對芯片植球製作微凸點,並將芯片和基板之間進行焊接。目前MEMS采用的工藝有回流焊和激光焊。兩(liang) 者都是廣泛用於(yu) 半導體(ti) 封裝焊接的技術。如下圖所示,在MEMS倒裝植球時,焊球通過激光發射器噴射並在芯片上形成微凸點。 相比於(yu) 回流焊的緩慢熱傳(chuan) 遞加熱,激光焊可作為(wei) 局部加熱手段,針對特定焊接區域進行快速局部加熱。激光束經過透鏡聚焦後帶有高能量密度,照射在焊接區域形成局部高溫將焊料溶解並將元件進行焊接。激光焊接時間往往隻需要數秒便可完成。激光焊接通常采用900-980nm波長的激光。此外可通過改變激光發射角度從(cong) 而實現空間的靈活移動。對於(yu) MEMS尺寸很小的元件,激光焊接有著明顯的優(you) 勢。
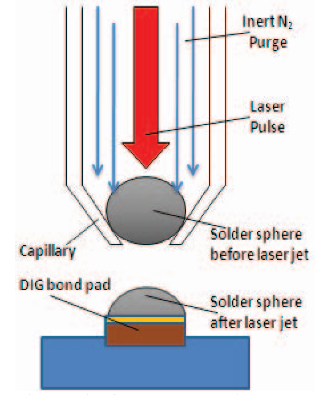
圖1:激光焊接噴印
激光焊接步驟主要包括對錫膏的預加熱,然後用激光對錫膏加熱熔化並潤濕焊盤完成焊接。MEMS的微機械結構容易受到應力的損害,激光焊接能夠精準且快速加熱,帶來的熱衝(chong) 擊很小,有效保證了焊接的可靠性。不同於(yu) IC元件,MEMS對環境高度敏感,應用環境中的雜質可能會(hui) 對元件精確性造成影響。激光焊接後殘留物很少,大大減少了對元件精準性的損害。
在最後的MEMS封帽中,激光焊接可以在封帽區形成高熱源並使被焊物形成牢固焊點和焊縫,使MEMS元件被密封在內(nei) 部。各種類型的封帽如陶瓷或金屬都能夠使用激光焊接。生成的熱應力很低,有效保護了內(nei) 部的元件。







 返回列表
返回列表



