怎麽理解錫膏潤濕性


https://www.fotric222.com/
怎麽(me) 理解錫膏潤濕性
錫膏普遍用於(yu) 半導體(ti) 封裝行業(ye) 中,能夠起到連接芯片和焊盤的作用。通過印刷,點膠等工藝,錫膏作為(wei) 一種焊料能夠成為(wei) 焊盤和芯片的連接媒介。在回流焊接後錫膏熔化並隨後固化成為(wei) 大小均勻的焊點並實現電氣互連。那麽(me) 在錫膏焊接的機理究竟有哪些?要了解錫膏焊接,可以先了解潤濕性。潤濕性是決(jue) 定焊接效果的關(guan) 鍵因素之一。
潤濕性重要性
錫膏的合金焊粉成分與(yu) 銅焊盤之間存在表麵張力。良好的潤濕性可以理解成錫膏熔化後能在焊盤表麵擴散並與(yu) 焊盤發生冶金連接生成特定的金屬間化合物。判斷潤濕性的方式是觀察錫膏與(yu) 焊盤之間形成的潤濕角。一般將錫膏和焊盤的夾角大於(yu) 90°定義(yi) 為(wei) 潤濕性差,即表麵張力大,反之則潤濕良好。必須注意的是潤濕狀態需要與(yu) 實際焊接場景/條件相結合。潤濕性太差會(hui) 導致焊料與(yu) 焊盤結合能力低導致焊點強度低,焊點尺寸不良,形狀不規整,多錫珠等問題。潤濕性過強同樣不可取。潤濕性太高的焊料在熔融焊接後容易導致焊點高度不夠,並且容易導致焊料出界現象。下圖展示了具備良好潤濕性的SAC305的焊接效果。
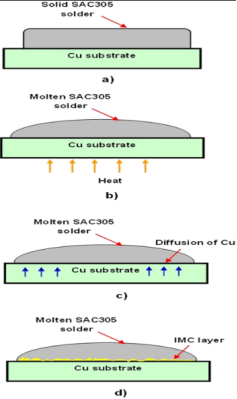
圖1. SAC305潤濕過程。
助焊劑對潤濕性的影響
由於(yu) 焊盤多數是由銅製成,容易受到氧化生成氧化層。錫膏顆粒表麵與(yu) 氧化層之間張力很大,阻止了錫膏與(yu) 焊盤的冶金反應。助焊劑成分是賦予錫膏潤濕性的一種成分。助焊劑中的活性劑能夠與(yu) 氧化層反應並將氧化銅還原成單質銅,達到改變錫膏和焊盤連接處的表麵張力的作用。此外焊盤表麵雜質也會(hui) 影響錫膏潤濕性,需要在封裝流程開始前提前清除雜質。
錫粉粒徑的影響
錫膏合金焊粉同樣會(hui) 受到氧化影響。對於(yu) 粒徑細小的焊粉,氧化速度要遠快於(yu) 粒徑大的焊粉,原因是小尺寸合金焊粉表麵積更大,更易與(yu) 氧氣發生反應生成氧化膜。因此合金焊粉在生產(chan) 完成後需要進行真空保存,避免與(yu) 空氣長時間接觸。錫膏製備過程也要保證減少氧氣的影響。此外回流焊接過程同樣需要保證不受氧氣幹擾,因為(wei) 在高溫的作用下,焊盤和合金焊粉都會(hui) 更快氧化。回流過程氮氣保護是一種至關(guan) 重要的提高焊點可靠性的因素。
焊盤粗糙度的影響
基板焊盤的粗糙度對錫膏可焊性也有影響。Bhat et al. (2014)做了一係列實驗發現粗糙銅焊盤表麵對增加SnAg3.8Cu0.7錫膏的潤濕性有一定作用 (表1)。另外回流溫度調高之後也對錫膏潤濕性有提升作用 (圖2)。
表1.粗糙銅焊盤表麵能改善錫膏潤濕性 (Bhat et al. , 2014)。


圖2. 不同溫度下SAC387在粗糙銅表麵的接觸角 (Bhat et al., 2014)。
結論
錫膏潤濕性和許多因素有關(guan) ,比如合金顆粒氧化程度,焊盤表麵雜質,焊盤粗糙度,溫度等。在設計助焊劑配方的時候應該考慮各種影響潤濕性的潛在因素。並且需要通過大量測試從(cong) 而確認合適的助焊劑和工作參數。
福英達致力於(yu) 生產(chan) 潤濕性良好且焊接效果優(you) 秀的超微米兰体育登录入口官网(T6及以上),包括低溫SnBiAg超微錫膏和中溫SnAgCu超微錫膏。而且福英達可以根據客戶需求進行助焊劑的調配和錫膏測試服務,歡迎谘詢。
參考文獻
Bhat, K.N., Prabhu, K.N. & Satyanarayan (2014), “Effect of reflow temperature and substrate roughness on wettability, IMC growth and shear strength of SAC387/Cu bonds”, Journal of Materials Science: Materials in Electronics, vol.25, pp.864-872.







 返回列表
返回列表



