混合集成電路封裝_福英達錫膏


混合集成電路封裝_福英達錫膏
混合集成電路是通過將裸芯片直接固定到基板並與(yu) 基板實現互連結構而形成的高組裝密度電路。混合集成電路可以是將兩(liang) 種或多種元件封裝到一起形成微電子電路,例如將一個(ge) 集成電路和一個(ge) 無源電子元件封裝到一起,並安裝在PCB上。製作混合集成電路是一個(ge) 較為(wei) 簡單的程序,大致步驟包括將IC和無源元件組裝到同一塊基板上,然後再將他們(men) 用塑料等材料封裝起來。將元件組裝到同一塊基板上可以減少焊點數量,並且減少原件間距和電流路徑。
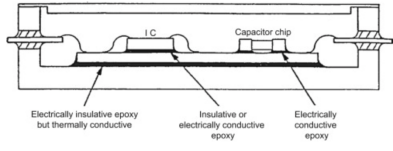
圖1. 混合集成電路。
混合集成電路可以分為(wei) 兩(liang) 大類,一種是薄膜混合集成電路,另一種是厚膜混合集成電路。薄膜混合集成電路的基板材料可以選擇玻璃或陶瓷,焊接後能帶來更好的散熱性能。基板上預製的互連導線和焊盤一般是通過物理/化學氣相沉積或濺射金屬薄膜所製成,然後通過光刻工藝對其蝕刻出特定圖案。氣相沉積通常采取閃蒸將金屬物質沉積在基板上。濺射法通過可以達到很高的薄膜沉積率並且不需要高溫處理。此外薄膜混合集成電路導線寬度和間距很小,通常為(wei) 3–5mils。
厚膜混合集成電路也選擇陶瓷材料例如氧化鋁,氮化鋁和氧化鈹作為(wei) 互連基板。不同的是厚膜混合集成電路采用絲(si) 網印刷技術在基板上塗覆錫膏等導電焊料形成較厚的膜。需要厚膜有良好的導電性,兼容性和黏著力。厚膜混合集成電路的導線寬度和間距很小。很多廠家會(hui) 選擇10-20mils的導線。相比更細的導線,稍粗點的導線能夠提高元件產(chan) 量。並且厚膜混合集成電路的比薄膜混合集成電路有著更好的成本優(you) 勢。
多芯片模組(MCM)
MCM是混合集成電路技術發展的一個(ge) 擴展產(chan) 物。混合集成技術對封裝的密度的提升造就了MCM的發展。這意味著MCM的基板上會(hui) 含有更多的集成電路芯片。MCM的種類有MCM-L (疊層), MCM-C (共燒陶瓷)和MCM-D (澱積)。MCM-基板可以是剛性,柔性或剛性柔性混合。剛性MCM-L基板通常由環氧基聚合物樹脂電介質製成,並用玻璃纖維加固。MCM-L封裝技術是其中最低密度的一種,自然而然製造的成本也最低。值得注意的是MCM-L和板上芯片封裝技術(COB)非常相似。MCM-C是以共燒陶瓷混合集成電路技術為(wei) 基礎而研發的封裝模組。陶瓷基板有高溫共燒和低溫共燒兩(liang) 種。
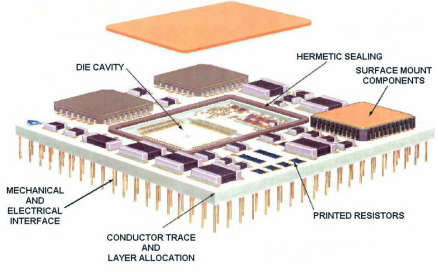
圖2. 一種MCM結構。
深圳市福英達為(wei) 客戶提供優(you) 質的超微米兰体育登录入口官网,米兰体育登录入口官网能用做集成電路封裝導電焊料。其中錫鉍銀米兰体育登录入口官网熔點溫度能低至139℃,適用於(yu) 低溫焊接的場景。福英達還可提供熔點達到280℃的金錫錫膏,滿足高溫焊接需求。此外福英達還有其他類型不同溫度的錫膏,歡迎了解。







 返回列表
返回列表



