倒裝凸點在不同回流次數後的可靠性-深圳市福英達


倒裝凸點在不同回流次數後的可靠性_深圳市福英達
倒裝技術封裝的電氣路徑長度比引線鍵合更短,因此能夠提供優(you) 異的電氣性能,高輸入/輸出密度和高互連速度。但是倒裝技術的成本也比引線鍵合高得多。因此有研究者提出了將無掩模化學晶片凸點技術與(yu) 化鎳浸金(ENIG)電鍍和鋼網錫膏印刷工藝相結合,減少了凸點下冶金(UBM)濺射和光刻工藝,以此解決(jue) 倒裝芯片工藝的高成本問題。
錫膏印刷到晶片上之後會(hui) 回流成為(wei) 微凸點。微凸點的可靠性是值得關(guan) 注的話題。Ha等人評估了SAC305/Sn63Pb37錫膏和ENIG UBM在多次回流的界麵反應和機械強度。倒裝器件采用了ENIG表麵處理,鍍有6μm厚的Ni-P層和0.15μm厚的Au層。焊盤直徑為(wei) 80μm,100μm和130μm。Sn63Pb37和SAC305的峰值回流溫度為(wei) 225和255°C。
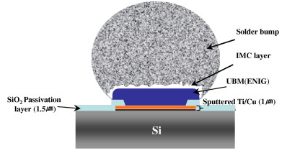
圖1. 倒裝焊點示意圖。
回流後微凸點的直徑為(wei) 130μm,160μm和190μm。在回流時ENIG層的Au首先溶入焊料中。對於(yu) Sn63Pb37錫膏,在焊料和Ni–P UBM的界麵處形成了Ni3Sn4 IMC層。這是由於(yu) Ni從(cong) Ni-P層中擴散出去並與(yu) 焊料Sn生成Ni3Sn4。此外,剛回流完成的凸點IMC較薄,隨著回流次數的增加IMC的厚度增加。
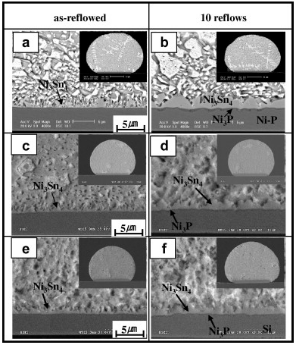
圖2. 回流後Sn63Pb37/ENIG界麵: (a, b)焊盤尺寸130μm; (c, d)焊盤尺寸100μm; (e, f)焊盤尺寸80μm。
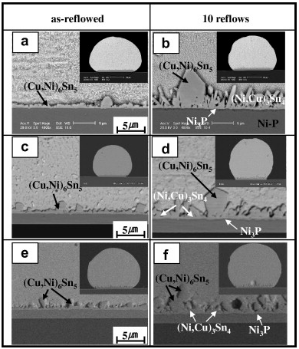
圖3. 回流後SAC305/ENIG界麵: (a, b)焊盤尺寸130μm; (c, d)焊盤尺寸100μm; (e, f)焊盤尺寸80μm。
SAC305錫膏在回流後在焊料和Ni-P層界麵處生成(Cu, Ni)6Sn5。隨著回流次數的增加,在界麵處形成了塊狀(Cu,Ni)6Sn5和針狀(Ni,Cu)3Sn4兩(liang) 種IMC。並且IMC的厚度隨著回流次數增加而增加。
在器件使用時候經常會(hui) 受到各種機械載荷和熱應力的影響。因此芯片凸點的可靠性極其重要。Ha等人發現凸點剪切力變化和回流次數沒有顯著關(guan) 係。尺寸大凸點的剪切力要高於(yu) 尺寸小的凸點。此外,SAC305凸點的剪切力要大於(yu) Sn63Pb37。在進行剪切後,剛回流的Sn63Pb37凸點的斷裂模式是韌性斷裂,且回流10次後依然是韌性斷裂。SAC305凸點在回流後為(wei) 韌性斷裂,但在回流10次後出現了小部分脆性斷裂。
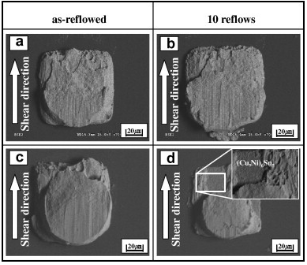
圖4. 剪切後的凸點失效表麵: (a, b)Sn63Pb37; (c, d)SAC305 (焊盤尺寸80μm)。
深圳市福英達能夠製造用於(yu) SMT和微凸點工藝的中溫超微錫膏(T6及以上)。福英達中溫錫膏如SAC305係列印刷性和可焊性優(you) 秀,能夠流暢印刷到基板上,回流後形成的焊點均勻且機械強度優(you) 秀。歡迎谘詢了解更多信息。
Ha, S.S., Kim, D.G., Kim, J.W., Yoon, J.W., Joo, J.H., Shin, Y.E. & Jung, S.B. (2007). Interfacial reaction and joint reliability of fine-pitch flip-chip solder bump using stencil printing method. Microelectronic Engineering, vol.84, pp.2640-2645.







 返回列表
返回列表



