BGA焊點在低溫環境的機械強度-福英達錫膏


BGA焊點在低溫環境的機械強度-福英達錫膏
在一些領域涉及了電子設備的低溫應用,比如航空領域和電信領域。電子設備在火星和月球表麵需要承受低於(yu) 零下100℃的工作環境。在如此低的溫度下運作,電子設備的焊點機械強度和導電導熱可靠性會(hui) 受到巨大的挑戰。由於(yu) 不同材料之間的熱膨脹係數不匹配,在焊點中會(hui) 存在剪切載荷,這可能導致焊點發生斷裂。
為(wei) 了更直觀了解焊點在低溫工作的可靠性,Li等人采用BGA結構Cu(Ni)/SAC305/Cu(Ni)焊點進行低溫剪切試驗。焊點的製造在BGA返修機中完成,峰值溫度為(wei) 250°C,停留時間為(wei) 50s。
在製造完SAC305焊點後,觀察到焊料基體(ti) 主要由富Sn枝晶,Sn,Cu6Sn5和Ag3Sn組成。當焊料與(yu) Cu焊盤互連時,焊料和焊盤界麵金屬間化合物(IMC)為(wei) Cu6Sn5,而焊料與(yu) Ni焊盤的界麵IMC為(wei) Ni3Sn4。通常來說Ni對IMC生長有一定抑製作用。因此焊料與(yu) Ni焊盤一側(ce) 的界麵IMC厚度較小。
在25℃的時候,Cu/SAC305/Cu焊點的剪切強度最低。這是因為(wei) Cu/SAC305/Cu焊點中的Cu6Sn5 IMC對焊料基體(ti) 的強化作用弱於(yu) SAC305/Ni焊盤中的Ni3Sn4 IMC。此外可以看到Cu/SAC305/Cu焊點隨著溫度的降低剪切強度一直上升。而SAC305/Ni焊點的剪切強度在降溫時經曆了上升階段,然後開始下降。峰值剪切強度在-75℃左右時出現。

圖1. BGA焊點在不同溫度下的剪切強度。
在25℃時,焊料基體(ti) 能看到有凹坑,表明斷裂傾(qing) 向於(yu) 發生在焊料基體(ti) 中,此時Cu/SAC305/Cu焊點的斷裂模式為(wei) 韌性斷裂。當溫度降至0°C,−25°C,−50°C和−75°C時,焊料基體(ti) 仍有凹坑,在焊料/IMC界麵也出現了部分斷裂,此時焊點同時出現韌性斷裂和脆性斷裂。當溫度下降到-100℃後,焊點和焊盤界麵處的IMC發生斷裂,意味著此時斷裂模式為(wei) 脆性斷裂。如果將焊料與(yu) Ni焊盤互連,隨著溫度降低焊點依舊會(hui) 經曆韌性斷裂到脆性斷裂的轉變。

圖2. 不同溫度下Cu/SAC305/Cu焊點的斷裂表麵: (a) 25 °C, (b) 0 °C, (c) −25 °C, (d) −50 °C, (e) −75 °C, (f) −100 °C, (g) −125 °C。
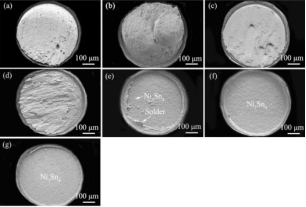
圖3. 不同溫度下Cu/SAC305/Ni焊點的斷裂表麵: (a) 25 °C, (b) 0 °C, (c) −25 °C, (d) −50 °C, (e) −75 °C, (f) −100 °C, (g) −125 °C。
深圳市福英達的中溫錫膏SAC305能夠用於(yu) 替代焊料球進行BGA工藝,通過鋼網將錫膏印刷到芯片焊盤上並回流收縮成球。SAC305錫膏熔點217℃,能夠用於(yu) 多次回流的首次回流,且焊點在高溫和低溫環境下仍能保持優(you) 秀的機械強度。
參考文獻
Li, W.Y., Gui, J., Qin, H.B. & Yang, D.G. (2022). Shear performance of microscale ball grid array structure Cu(Ni)/Sn–3.0Ag–0.5Cu/Cu(Ni) solder joints at low temperatures. Materialstoday Communications, vol.30.







 返回列表
返回列表



