SMT工藝分享:0.4mm間距CSP-深圳福英達


SMT工藝分享:0.4mm間距CSP
隨著後摩爾時代的到來,電子元器件逐漸向小型化,結構複雜化,功能集成化方向發展。激光焊接以其非接觸,選擇性局部加熱和高精度的獨特優(you) 勢而成為(wei) 改進焊接工藝的寵兒(er) 。可以知道的是激光焊接可以解決(jue) 傳(chuan) 統回流焊中精度難以提高,小批量生產(chan) 成本高的問題。由於(yu) 金屬間化合物對焊點可靠性起到至關(guan) 重要影響,因此研究者們(men) 急於(yu) 發現激光焊接對焊點金屬間化合物演變的影響。
工藝原理
CSP(Chip Scale Packag,芯片級封裝)焊端為(wei) ф0.25m球、有少許的空間吸納熔融焊錫,同時,由於(yu) 焊膏先融化、焊球後融化的特性,一般情況下不會(hui) 出現橋連的問題,主要問題是印刷少印而導致球窩、開焊等現象,因此,0.4mm間距CSP的印刷目標是獲得足夠的焊膏量。
基準工藝
(1)模板厚度0.08mm,模板開口ф0.25mm
(2)推薦采用 FG 模板。
接受條件
可接受條件
(1)焊膏圖形中心偏離焊盤中心小於(yu) 0.05mm,如圖8-52(a)所示
(2)焊膏量為(wei) 75%~125%(采用 SPI)。
(3)焊膏覆蓋麵積大於(yu) 或等於(yu) 模板開口麵積的70%,如圖8-52(b)所示。
(4)無漏印,擠印引發的焊音與(yu) 焊盤最小間隔大於(yu) 或等於(yu) 0.5mm
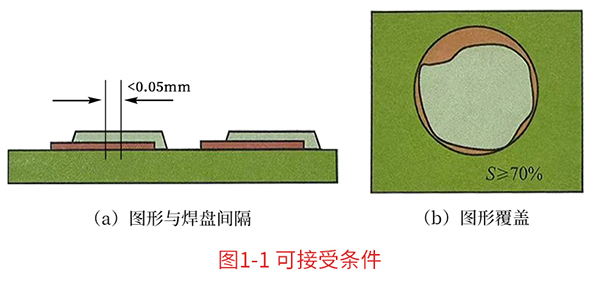
圖源自:(SMT工藝不良與(yu) 組裝可靠性書(shu) 籍)
不接受條件
(1)圖形中心偏離焊盤中心大於(yu) 0.05mm,如圖8-53(a)所示。
(2)焊膏量超出 75%~125%範圍(采用 SPI)。
(3)圖形覆蓋麵積小於(yu) 模板開口麵積的 70%,如圖8-53(b)所示。
(4)焊膏漏印、嚴(yan) 重擠印與(yu) 拉尖。
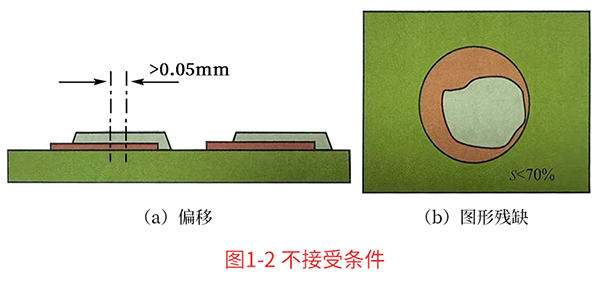
-未完待續-
*免責聲明:本文由作者原創。文章內(nei) 容係作者個(ge) 人觀點,轉載僅(jin) 為(wei) 了傳(chuan) 達一種不同的觀點,不代表對該觀點讚同或支持,如有侵權,歡迎聯係我們(men) 刪除!除了“轉載”文章,本站所刊原創內(nei) 容著作權屬於(yu) 深圳福英達,未經本站同意授權,不得重製、轉載、引用、變更或出版。







 返回列表
返回列表



