CSP(Chip Scale Package)封裝工藝詳解-深圳福英達


CSP(Chip Scale Package)封裝工藝詳解
工藝原理
CSP(Chip Scale Package,芯片級封裝)技術是一種先進的封裝技術,其焊端通常設計為(wei) 直徑0.25mm的焊球。這種設計不僅(jin) 減小了封裝尺寸,還提高了集成度。在焊接過程中,焊膏首先融化,隨後焊球融化,這種順序融化機製有助於(yu) 避免焊球間的橋連問題,但可能因印刷過程中的少印而導致球窩、開焊等缺陷。因此,對於(yu) 0.4mm間距的CSP,確保印刷過程中獲得足夠的焊膏量是關(guan) 鍵。
基準工藝
為(wei) 了優(you) 化CSP的焊接效果,基準工藝設定如下:
模板厚度:0.08mm。這一厚度選擇旨在平衡焊膏的填充性和溢出控製,確保焊膏能夠均勻且適量地覆蓋焊盤。
模板開口直徑:ф0.25mm,與(yu) 焊球直徑相匹配,以確保焊膏能夠準確、完整地填充到焊球下方的區域。
模板類型:推薦使用FG模板。FG模板(Fine Grain模板)以其精細的網孔結構和優(you) 異的脫模性能,有助於(yu) 實現高精度的焊膏印刷。
接受條件
可接受條件:
焊膏圖形中心位置:焊膏圖形中心偏離焊盤中心應小於(yu) 0.05mm,以確保焊膏的準確位置,避免焊接不良。
焊膏量:焊膏量覆蓋率超出焊盤75%~125%的範圍(通過SPI檢測)。這一範圍確保了焊膏的充足性,同時避免了過量焊膏可能導致的短路問題。
焊膏覆蓋麵積:焊膏覆蓋麵積應大於(yu) 或等於(yu) 模板開口麵積的70%,以確保焊膏能夠充分覆蓋焊盤,提高焊接的可靠性和穩定性。
印刷質量:
無漏印現象,且擠印引發的焊膏與(yu) 焊盤最小間隔應大於(yu) 或等於(yu) 0.5mm²,以避免短路風險。
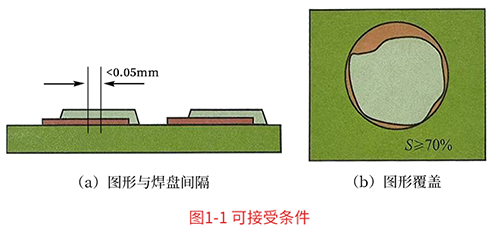
不接受條件
焊膏圖形中心位置偏移:圖形中心偏離焊盤中心大於(yu) 0.05mm,這可能導致焊接不良,產(chan) 生錫珠,影響封裝質量。
焊膏量異常:焊膏量覆蓋率超出焊盤75%~125%的範圍,無論是過多還是過少,都可能對焊接質量產(chan) 生不利影響。
焊膏覆蓋麵積不足:圖形覆蓋麵積小於(yu) 模板開口麵積的70%,這可能導致焊盤部分區域無焊膏覆蓋,進而影響焊接的可靠性。
印刷缺陷:出現焊膏漏印、嚴(yan) 重擠印與(yu) 拉尖等缺陷,這些都會(hui) 直接影響焊接的質量和穩定性,因此不被接受。
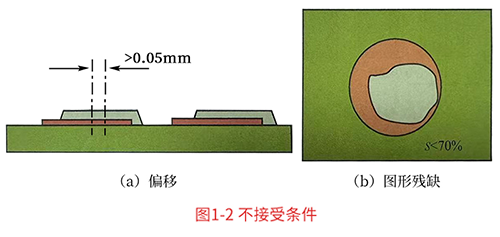
總的來說,CSP封裝工藝的成功實施需要嚴(yan) 格控製焊膏的印刷過程,確保焊膏的準確位置、適量填充和良好覆蓋,以滿足嚴(yan) 格的焊接質量要求。
-未完待續-
*免責聲明:本文由作者原創。文章內(nei) 容係作者個(ge) 人觀點,轉載僅(jin) 為(wei) 了傳(chuan) 達一種不同的觀點,不代表對該觀點讚同或支持,如有侵權,歡迎聯係我們(men) 刪除!除了“轉載”文章,本站所刊原創內(nei) 容著作權屬於(yu) 深圳福英達,未經本站同意授權,不得重製、轉載、引用、變更或出版。








 返回列表
返回列表



