封裝過程中開路引起的原因及優化措施-深圳福英達


封裝過程中開路引起的原因及優(you) 化措施
在電子製造中,(Open Circuit)是一個(ge) 常見問題,它會(hui) 導致電路中的電流無法流通,從(cong) 而影響整個(ge) 電子產(chan) 品的功能。針對開路原因及其改進建議,我們(men) 可以進一步細化和擴展這些內(nei) 容。
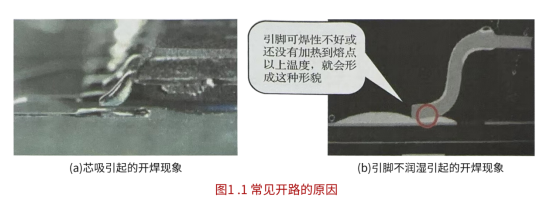
產(chan) 生原因及詳細分析
1.1 引腳共麵性引起的開路
共麵性問題:元器件的引腳在高度上可能存在微小差異(如QFP引腳±25μm),這種差異在焊接過程中可能導致某些引腳未能與(yu) 焊料充分接觸。
焊膏厚度:焊膏印刷的厚度同樣影響焊點質量。過薄的焊膏可能無法覆蓋所有引腳,而過厚的焊膏則可能引發其他問題(如橋連)。
解決(jue) 方案:除了減少引腳的非共麵性和調整焊膏厚度外,還可以考慮使用具有更好共麵性的元器件,或采用先進的焊接技術(如激光焊接)來確保焊點質量。
1.2 引腳氧化引起的枕形焊點
氧化層:引腳表麵的氧化層會(hui) 阻止焊料與(yu) 引腳之間的潤濕,導致焊點不良。
解決(jue) 方法:
預處理:在焊接前對引腳/焊盤進行清洗或去氧化處理。
使用高活性焊料:選擇具有更高活性的焊料,以提高潤濕性。
控製焊接環境:保持焊接區域的清潔和幹燥,采用惰性氣體(ti) 氛圍,減少氧化可能。
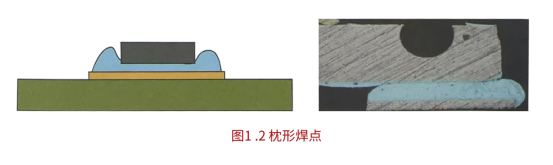
1.3 其他開路原因
立碑和芯吸:這些現象可能導致焊點形狀不規則,影響電氣連接。
放置對準:元器件或印製板放置不準確也會(hui) 導致開路。
翹曲:印製板或元器件的翹曲可能使焊點受到應力,從(cong) 而引發開路。
解決(jue) 方案:
優(you) 化焊接工藝,減少立碑和芯吸的發生。
提高自動化貼裝設備的精度,確保元器件放置準確。
設計時考慮印製板和元器件的翹曲問題,采取適當的加固措施。
改善及優(you) 化措施的詳細實施
(1) 參考解決(jue) 潤濕不良、立碑和芯吸的辦法
潤濕不良:采用前麵提到的清洗、去氧化、使用活性焊料等方法。
立碑:調整焊接參數(如預熱溫度、焊接時間)、優(you) 化焊盤設計、使用助焊劑等。
芯吸:控製焊接過程中的氣體(ti) 流動、使用合適的焊料配方等。
(2) 使元器件加固或避免局部化的加熱
加固:在焊接前對元器件進行加固處理,以減少焊接過程中的移動和變形。
均勻加熱:優(you) 化加熱設備,確保焊接過程中熱量分布均勻,避免局部過熱。
(3) 提高貼片對準度
高精度設備:采用更高精度的自動化貼裝設備。
視覺檢測係統:在貼裝過程中引入視覺檢測係統,實時監控元器件位置並進行調整。
(4) 減少印製板與(yu) 元器件之間的溫度梯度
預熱:在焊接前對印製板和元器件進行預熱,使它們(men) 達到相近的溫度。
優(you) 化加熱曲線:根據印製板和元器件的材料特性,設計合理的加熱曲線,以減少溫度梯度。
(5) HASL印製板時避免形成過多的金屬間化合物
控製鍍層厚度:在HASL(熱風整平)過程中控製鍍層厚度,避免過厚導致金屬間化合物過多。
選擇合適材料:選擇不易形成金屬間化合物的鍍層材料。
後處理:在焊接後進行適當的後處理,以去除多餘(yu) 的金屬間化合物或改善焊點質量。
-未完待續-
*免責聲明:本文由作者原創。文章內(nei) 容係作者個(ge) 人觀點,轉載僅(jin) 為(wei) 了傳(chuan) 達一種不同的觀點,不代表對該觀點讚同或支持,如有侵權,歡迎聯係我們(men) 刪除!除了“轉載”文章,本站所刊原創內(nei) 容著作權屬於(yu) 深圳福英達,未經本站同意授權,不得重製、轉載、引用、變更或出版。







 返回列表
返回列表



